
Главная страница Случайная страница
Разделы сайта
АвтомобилиАстрономияБиологияГеографияДом и садДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеталлургияМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРелигияРиторикаСоциологияСпортСтроительствоТехнологияТуризмФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Определение ширины запрещенной зоны полупроводников методом измерения обратных токов p-n-переходов
|
|
МИНОБРНАУКИ РОССИИ
Федеральное государственное бюджетное образовательное учреждение высшего профессионального образования
«Юго-Западный государственный университет»
(ЮЗГУ)
Кафедра конструирования и технологии электронно- вычислительных средств
УТВЕРЖДАЮ
Первый проректор –
проректор по учебной работе
____________ Е.А. Кудряшов
«___» ___________ 2012 г.
ОПРЕДЕЛЕНИЕ ШИРИНЫ ЗАПРЕЩЕННОЙ ЗОНЫ ПОЛУПРОВОДНИКОВ МЕТОДОМ ИЗМЕРЕНИЯ ОБРАТНЫХ ТОКОВ p-n-ПЕРЕХОДОВ
Методические указания по выполнению лабораторной работы по дисциплинам
«Физические основы микроэлектроники»
для студентов специальности 210202.65 и направления подготовки бакалавров 210200.62
Курск 2012
УДК 621.382
Составители: А.В. Кочура, В.В. Умрихин
Рецензент
Доктор физико-математических наук, профессор А.П. Кузьменко
Определение ширины запрещенной зоны полупроводников методом измерения обратных токов p-n - переходов: методические указания по выполнению лабораторной работы по дисциплине «Физические основы микроэлектроники» / Юго-Зап. гос. ун-т.; сост.: А. В. Кочура, В. В. Умрихин. Курск, 2012. 12 с.: ил. 6, Библиогр.: с. 12.
Содержатся методические рекомендации по экспериментальному определению ширины запрещенной зоны полупроводников, используемых для создания диодов.
Указывается порядок выполнения лабораторной работы.
Методические указания соответствуют требованиям программы, утвержденной учебно-методическим объединением по специальностям автоматики и электроники (УМО АЭ).
Предназначены для студентов специальности 210202.65, и направлений подготовки бакалавров 210200.62.
Текст печатается в авторской редакции
Подписано в печать. Формат 60  84 1/16.
84 1/16.
Усл. печ. л.. Уч.-изд. л.. Тираж 30 экз. Заказ. Бесплатно.
Юго-Западный государственный университет.
— Регулярная проверка качества ссылок по более чем 100 показателям и ежедневный пересчет показателей качества проекта.
— Все известные форматы ссылок: арендные ссылки, вечные ссылки, публикации (упоминания, мнения, отзывы, статьи, пресс-релизы).
— SeoHammer покажет, где рост или падение, а также запросы, на которые нужно обратить внимание.
SeoHammer еще предоставляет технологию Буст, она ускоряет продвижение в десятки раз, а первые результаты появляются уже в течение первых 7 дней. Зарегистрироваться и Начать продвижение
305040, г. Курск, ул. 50 лет Октября, 94
1. ЦЕЛЬ РАБОТЫ
Изучить методику определения ширины запрещенной зоны методом обратных токов p-n-переходов.
2. Энергетический спектр электронов в кристалле
Запрещенная зона - интервал энергий, разделяющий валентную зону и зону проводимости. Ширина запрещенной зоны определяет физико-химические свойства материалов электронной техники. Целью настоящей работы является определение ширины запрещенной зоны полупроводника методом измерения температурной зависимости обратных токов p-n перехода.
Каждый электрон, входящий в состав атома, обладает определенной полной энергией, а на зонной диаграмме занимает соответствующий энергетический уровень. В твердом теле, благодаря взаимодействию атомов, энергетические уровни расщепляются в энергетические зоны. Они состоят из отдельных близко расположенных по энергии уровней, число которых соответствует количеству однородных атомов в данном кристалле (рис.2.1).

Рис.2.1. Энергетические зоны в полупроводнике: 1, 2, 3, 4 - разрешенные зоны, 5 - запрещенные зоны, DE - ширина запрещенной зоны.
Энергетическую зону или совокупность нескольких перекрывающихся энергетических зон, которые образовались в результате расщепления одного или нескольких энергетических уровней отдельного атома, называют разрешенной зоной. Электроны в твердом теле могут иметь энергии, соответствующие разрешенной зоне. Энергетические уровни валентных электронов при расщеплении образуют валентную зону. Разрешенные энергетические уровни, свободные от электронов в невозбужденном состоянии атома, расщепляясь, образуют одну или несколько свободных зон. Нижнюю из свободных зон называют зоной проводимости. Наибольший интерес представляют валентная зона и зона проводимости, так как от их взаимного расположения и от степени их заполнения электронами зависят электрические, оптические и другие свойства твердых тел. По характеру заполнения зон все кристаллы подразделяются на два класса. К первому относятся материалы, у которых над полностью заполненной зоной располагается частично заполненная зона (рис.2.2).

Рис.2.2. Образование частично заполненной зоны
Электроны частично заполненной зоны под воздействием внешнего электрического поля могут увеличивать свою энергию, переходя на вышележащие свободные уровни. Это означает, что в кристалле, обладающем такой зонной структурой, даже при наличии слабого электрического поля в отсутствии других энергетических воздействий (свет, повышение температуры и т.д.) возможно направленное перемещение электронов, то есть протекание электрического тока. Таким образом, кристаллы, имеющие частично заполненную разрешенную зону, относятся к проводникам.
— Разгрузит мастера, специалиста или компанию;
— Позволит гибко управлять расписанием и загрузкой;
— Разошлет оповещения о новых услугах или акциях;
— Позволит принять оплату на карту/кошелек/счет;
— Позволит записываться на групповые и персональные посещения;
— Поможет получить от клиента отзывы о визите к вам;
— Включает в себя сервис чаевых.
Для новых пользователей первый месяц бесплатно. Зарегистрироваться в сервисе
К другому классу относятся материалы, у которых при температуре абсолютного нуля над полностью заполненными зонами располагаются пустые (рис.2.3).

Рис.2.3. Зонная диаграмма полупроводника
Такую структуру зон имеют, например, элементы IV группы - углерод в модификации алмаза, кремний, германий, серое олово, а также многие химические соединения - окислы металлов, нитриды, карбиды и т.д. В полностью заполненной валентной зоне электроны лишены возможности изменить свое состояние под действием приложенного электрического поля, т.е. не способны участвовать в образовании тока. Не дает вклада в электропроводность и совершенно свободная зона проводимости.
Однако если ширина запрещенной зоны невелика, то при повышении температуры возможен переход валентных электронов в зону проводимости. Количество таких электронов экспоненциально увеличивается с ростом температуры. Следует заметить, что с переходом электронов в зону проводимости появляются вакантные уровни в валентной зоне. Это означает, что для валентных электронов то же появляется возможность изменить свою энергию, т.е. участвовать в образовании тока. Таким образом, в кристаллах с узкой запрещенной зоной эти материалы являются полупроводниками. При комнатной температуре ширина запрещенной зоны D E у кремния равна 1, 12 эВ; у германия D E = 0, 72 эВ; у арсенида галлия D E = 1, 43 эВ; у карбида кремния 2, 4 - 3, 4 эВ (для разных политипов).
Если запрещенная зона достаточно широкая, то переход валентных электронов в зону проводимости маловероятен. Такие твердые тела являются диэлектриками. Таким образом, диэлектрики отличаются от полупроводников лишь шириной запрещенной зоны. Условно к диэлектрикам относятся вещества, имеющие D Е > 3 эВ, а к полупроводникам - D Е < 3 эВ.
Ширина запрещенной зоны изменяется с изменением температуры. Происходит это в результате:
- изменения амплитуды тепловых колебаний атомов кристаллической решетки;
- изменения межатомных расстояний, т.е. объема тела.
С повышением температуры в первом случае ширина запрещенной зоны уменьшается, во втором случае может как уменьшаться, так и увеличиваться в зависимости от зонной структуры. У большинства полупроводников ширина запрещенной зоны с повышением температуры уменьшается.
3. Электронно-дырочный переход
Электронно-дырочным переходом (p-n-переходом) называется переходной слой на границе полупроводников с разными типами проводимости (рис.3.1). Одним из основных свойств такого перехода является односторонняя проводимость.
Вследствие различия концентраций электронов и дырок в n- и p-областях создается диффузное движение основных носителей через p-n переход, выравнивающее концентрации дырок и электронов в полупроводнике. Диффузионное перераспределение носителей заряда происходит до тех пор, пока их средняя энергия в обеих частях кристалла не сравняется. Иначе говоря, в стационарном состоянии при отсутствии внешнего электрического поля диффузионные токи электронов и дырок должны быть уравновешены встречными токами дрейфа электронов и дырок во внутреннем электрическом поле p-n-перехода.
Изменение внешнего напряжения, приложенного к p-n-переходу, приводит к изменению тока через переход. Зависимость между током и напряжением может быть получена аналитически и представлена графически в виде вольтамперной характеристики.
Если к p-n-переходу подключить внешний источник постоянного тока так, как показано на рис.3.1 (так называемое обратное включение p-n-перехода), то под влиянием поля Евнешн возникает поток электронов из p-области в n-область, а в обратном направлении будут переноситься дырки.
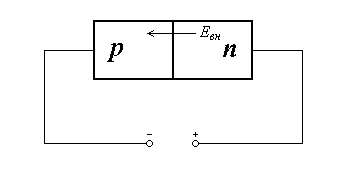
Рис.3.1. Обратное включение p-n-перехода
Поток дырок из p-области в n-область и электронов из n-области в p-область ограничен потенциальным барьером p-n-перехода. Степень ограничения тем больше, чем выше обратное напряжение. Вследствие этого при достаточно большом напряжении величина тока через обратно включенный p-n-переход (обратного тока) будет определяться только количеством неосновных носителей заряда, т.е. концентрацией электронов в p-области и дырок в n-области. Эта концентрация постоянна и зависит только от скорости возникновения неосновных носителей. Поэтому, если генерация носителей не зависит от напряжения, приложенного к переходу, то обратный ток также не будет зависеть от напряжения. Следует еще раз подчеркнуть, что это условие справедливо только при достаточно высоком напряжении на переходе (рис.3.2).
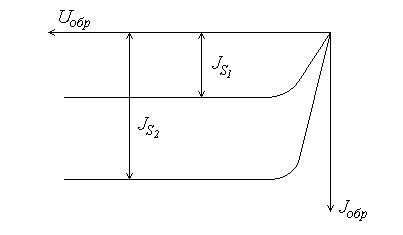
Рис.3.2. Обратная ветвь вольт-амперной характеристики
идеального p-n-перехода
Величина JS называется током насыщения. Плотность тока насыщения jS =JS / S (S -площадь p-n-перехода) будет пропорциональна концентрации неосновных носителей и скорости их возникновения:
 , (3.1)
, (3.1)
где Dn , Dp - коэффициенты диффузии электронов и дырок соответственно; Ln , Lp - диффузионная длина электронов и дырок соответственно.
Подставим в (3.1) известные соотношения
 ;
;  ,
,
где np и pn - концентрация электронов в p-области и дырок в n-области соответственно; pp и nn - концентрация дырок в p-области и электронов в n-области соответственно; ni - концентрация собственных носителей заряда.
Диффузионная длина электронов и дырок определяются из выражений:
 ;
;  ,
,
где tp, tn - время жизни дырок и электронов соответственно.
После подстановки получим
 . (3.2)
. (3.2)
В случае несимметричного p-n-перехода (они чаще всего встречаются на практике) обычно pp > > nn . Поэтому выражение (3.2) можно записать в следующем виде:
 , (3.3)
, (3.3)
где  - концентрация доноров.
- концентрация доноров.
Известно, что
 , (3.4)
, (3.4)
где Nс , Nv - эффективные плотности электронных состояний в зоне проводимости и валентной зоне соответственно; D E - ширина запрещенной зоны; k - постоянная Больцмана; T - абсолютная температура.
Если предположить, что при данной температуре все атомы доноров ионизированы, то зависимость всех остальных величин в выражении (3.3) от температуры будет более слабой по сравнению с экспоненциальным членом. Поэтому следует ожидать, что при обратном напряжении в области насыщения ток будет расти с температурой пропорционально  .
.
Исходя из этого, можно определить ширину запрещенной зоны полупроводника по наклону зависимости 
 . (3.5)
. (3.5)
Выше предполагалось, что генерация носителей заряда в самом переходе отсутствует. Однако на практике, как правило, насыщение обратного тока выражено слабо (см.рис.3.3), особенно в случае p-n-переходов на кремнии и арсениде галлия. Это объясняется генерацией и рекомбинацией носителей в непосредственной близости от геометрической плоскости p-n-перехода (в обедненных слоях), поверхностными явлениями и рядом других причин.
На рис.3.3 сплошной линией показана вольт-амперная характеристика реального диода, а пунктиром - идеализированного p-n-перехода. Идеально обратную вольтамперную характеристику реального p-n-перехода можно получить, если наклонный участок ветви обратного тока в области больших значений напряжения перенести в начало координат, как показано стрелкой (см.рис.3.3), а затем графически вычесть штрихпунктирную прямую из экспериментальной  кривой.
кривой.
Величину тока насыщения JS так же можно найти, если пpодолжить (экстpаполиpовать) линейный участок J (U) - кpивой до пеpесечения с осью кооpдинат (метод экстpаполяции, см.рис.3.3).
По значениям JS, найденным таким образом при двух различных температурах, можно согласно выражению (3.5) рассчитать ширину запрещенной зоны полупроводника.

Рис.3.3. Обpатная ветвь вольт-ампеpной хаpактеpистики
pеального p-n-пеpехода
4. Описание установки
1. Для выполнения работы используется стенд ЛР№2. Стенд содержит исследуемый диод Д2Е, электрическую печь, устройство измерения температуры на основе терморезистора, регулируемый источник питания, встроенный вольтметр и микроамперметр для измерения напряжения и величины обратного тока.
2. Перед включением стенда в сеть необходимо тумблеры " СЕТЬ " и " ПОДОГРЕВ " установить в положение " ВЫКЛ. ", а ручки " ПОДОГРЕВ " и " РЕГ.НАПРЯЖЕНИЯ " - в крайнее левое положение.
3. Подключите стенд к сети 220 В, 50 Гц.
5.Порядок работы
1. Включите стенд, для чего тумблер " СЕТЬ " установите в положение " ВКЛ. ", при этом должна загореться сигнальная лампочка, а прибор " Т ° С " должен показать значение температуры в зоне исследуемого диода в градусах Цельсия.
2. Изменяя величину обратного напряжения на диоде, с помощью потенциометра " РЕГ.НАПРЯЖЕНИЯ " замерить и занести в таблицу значение  при Т1= Tкомн, T2= 30 ° C, T3= 50 ° C.
при Т1= Tкомн, T2= 30 ° C, T3= 50 ° C.
Таблица 5.1
 Uобр В
Jобр mА Uобр В
Jобр mА
| 0, 5 | 1, 0 | 2, 0 | 4, 0 | 6, 0 | 8, 0 | 10, 0 |
| Т1 = | |||||||
| T2 = | |||||||
| T3 = |
3. Для подогрева диода необходимо тумблер " ПОДОГРЕВ " установить в положение " ВКЛ. " и с помощью потенциометра подобрать соответствующую скорость подогрева. Для повышения точности результатов эксперимента, учитывая инерциальность разогрева электрической печи, терморезистора и исследуемого диода, необходимо перед съемом данных при каждой заданной температуре выдерживать установку 1-2 минуты.
4. По полученным результатом рассчитать ширину запрещенной зоны для различных сочетаний температур Ткомн - 30 ° С, Ткомн - 50 ° С, 30 - 50 ° С. Постоянная Больцмана k = 8, 62 × 10 -5 эВ × град. При расчетах температура Т в градусах К.
5. Сделать вывод по работе.
6. Контрольные вопросы
1. Чем отличаются энергетические спектры электронов в кристалле и в изолированном атоме?
2. Что понимается под валентной зоной, зоной проводимости и запрещенной зоной?
3. От чего зависит ширина запрещенной зоны?
4. Какова ширина запрещенной зоны у различных твердых тел?
5. Каким методом можно определить ширину запрещенной зоны?
6. Что понимается под обратной вольтамперной характеристикой p-n-перехода?
7. Какие факторы влияют на величину обратного тока в области насыщения?
8. Почему для определения ширины запрещенной зоны методом p-n- перехода необходима температурная зависимость обратного тока?
9. По каким соображениям в данной работе измеряется семейство обратных вольт-амперных характеристик p-n-перехода при различных температурах ( , где T - параметр) вместо одной зависимости
, где T - параметр) вместо одной зависимости  ?
?
10. Какова методика расчета ширины запрещенной зоны?
БИБЛИОГРАФИЧЕСКИЙ СПИСОК
1. Епифанов Г.Н. Физические основы микроэлектроники. М.: Советское радио, 1971. 375 с.
2. Епифанов Г.Н. Физика твердого тела. М.: Высшая школа, 1977. 288с.
3. Дулин В.Н. Электронные приборы. М.: Энергия, 1977. 424 с.
4. Смит З. Полупроводники. М.: Мир, 1982. 560 с.
5. Росадо Л. Физическая электроника и микроэлектроника. М.: Высшая школа, 1991. 351 с.
