
Главная страница Случайная страница
Разделы сайта
АвтомобилиАстрономияБиологияГеографияДом и садДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеталлургияМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРелигияРиторикаСоциологияСпортСтроительствоТехнологияТуризмФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Разгерметизацию вакуумной камеры и выгрузку обработанных изделий.
|
|
С помощью вакуумно-плазменного травления можно обрабатывать полупроводниковые материалы, металлы, диэлектрики, окислы, нитриды, карбиды, алмаз, камни, высокомолекулярные соединения и т.д., причем как в монолитном, так и в тонкопленочном виде. В качестве инструмента травления используются: газоразрядная плазма (инертные и химически активные газы); ионный луч (Ar+, Kr+, Cl+, F+ и др.); атомный и молекулярный пучок (Ar, Kr, Cl2, F2, O2, H2 и др.). Глубина травления может составлять от 0, 05 до нескольких микрометров, а минимальная ширина линии травлении – 0, 1 – 0, 5 мкм.
В зависимости от вида обрабатываемого материала, требований по точности размеров микроструктур и производительности оборудования применяются различные способы вакуумно-плазменного травления (Табл.7 и 8). При использовании шлюзовых загрузочных систем главным резервом повышения производительности оборудования является скорость травления, которая в зависимости от применяемого способа может колебаться от 0, 01 до 500 нм/с.
При ионном травлении (" ИТ") скорость травления (физического распыления материала) равна:
 , м/с;
, м/с;
где ji – плотностьионного тока, А/м2; S – коэффициент распыления, атом/ион; M – молекулярная масса, кг/кмоль; qe - заряд электрона, Кл; NA - число Авогадро, молекул/кмоль; r - плотность материала, кг/м3.
При химическом травлении (" ХТ") скорость травления (спонтанной химической реакции) равна:
 , м/с;
, м/с;
где q хач – плотность потока химически активных частиц (ХАЧ) на поверхность материала, ХАЧ/(м2.с); e хр - вероятность спонтанной химической реакции; y хр - коэффициент выхода материала в результате химической реакции, атом/ХАЧ (для реакции Si + 4F ® SiF4 y хр= 0, 25 атом/ХАЧ). Величину q хач можно рассчитать по следующей формуле:
 ,
,
где  - парциальное давление ХАЧ, Па; k - постоянная Больцмана, Дж/К; T - температура стенок вакуумной камеры, К. Величину e хр можно рассчитать по следующей формуле:
- парциальное давление ХАЧ, Па; k - постоянная Больцмана, Дж/К; T - температура стенок вакуумной камеры, К. Величину e хр можно рассчитать по следующей формуле:
 ,
,
где Схр – предэкспоненциальный множитель, не зависящий от температуры; Eакт - энергия активации спонтанной химической реакции, Дж. В технологии микроэлектроники типичными химическими реакциями на подложке являются: Si + 4F· ® SiF4; SiO2 + 4F· ® SiF4 + O2; Si3N4 + 12F· ®3SiF4 + 2N2 и т.п
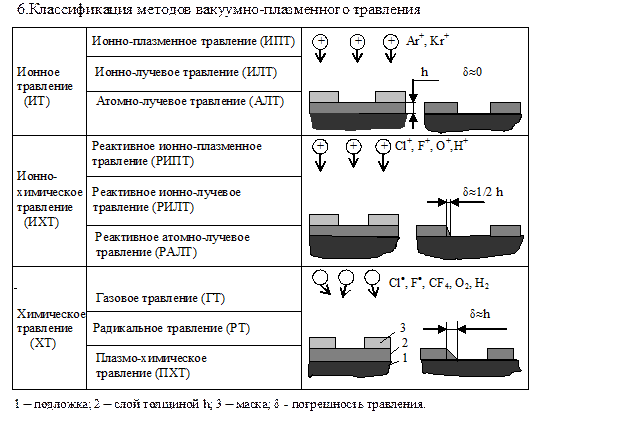
При ионно-химическом травлении (" ИХТ") скорость травления определяется как сумма VИХТ = VИТ + VХТ.
Селективность травления, т.е. возможность обрабатывать различные материалы, зависит от эффекта, лежащего в основе удаления материала с обрабатываемой поверхности. Физическим распылением можно обрабатывать практически любые материалы; скорость травления различных материалов зависит только от коэффициента распыления. Химическое взаимодействие наоборот весьма избирательно к различным материалам.
Погрешность травления, т.е. отклонение получаемых размеров от размеров маски, зависит от показателей изотропности травления. Строгая направленность обработки ускоренными частицами (заряженными ионами, нейтрализованными атомами или молекулами) способствует уменьшению погрешности размеров благодаря преимущественному травлению перпендикулярно поверхности, т.е. в глубь материала (см. Табл.7, Рис.27 а). Травление электрически нейтральными частицами (молекулами, атомами и радикалами), не имеющими преимущественного направления движения, вызывает появление погрешности размеров обработки за счет изотропного травления как перпендикулярно поверхности, т.е. в глубь материала, так и параллельно ей, т.е. под маску (Рис.27 б).
При ионном травлении погрешность размеров обработки может появиться при неправильно выбранной толщине маски. Если толщина маски намного больше толщины вытравливаемого слоя, то распыляемые атомы осаждаются на боковые стенки маски и изменяют ее размеры (длину, ширину или диаметр окна). При этом соответствующие размеры обрабатываемого слоя уменьшаются. Если толщина маски меньше или равна толщине обрабатываемого слоя, то материал маски может стравиться быстрее, чем материал слоя и его размеры могут стать больше требуемых.

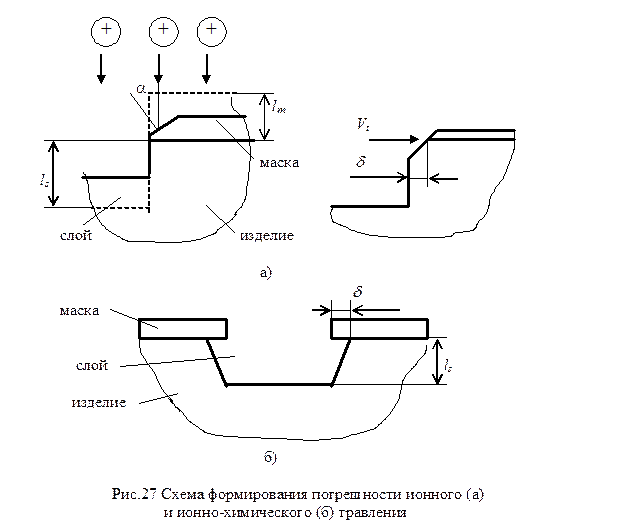
Оптимальная толщина маски при ионном травлении рассчитывается по следующей методике:
- максимальное время травления маски t1 толщиной lm без погрешности d равно
 ,
,
где Vm (a)= Vm (0) /Cosa – скорость травления маски под углом a, возникающим в результате более интенсивного распыления скругленных кромок маски (Рис.27 а); Vm (0) – скорость травления маски при a = 0;
- время травления слоя t на заданную глубину ls равно
 ,
,
где Vs (0) – скорость травления слоя при a = 0;
- скорость бокового травления маски Vt равна
 ;
;
- погрешность травления d равна
 ;
;
- оптимальная толщина маски  равна (при d=0)
равна (при d=0)
 .
.
К материалам маски при ионном травлении предъявляются следующие требования: высокая разрешающая способность; термостойкость; минимальная скорость травления по отношению к скорости травления слоя. Применяются маски из фольги (трафареты) с минимальным размером рисунка 30 – 50 мкм и тонкопленочные (контактные) маски с минимальным размером рисунка 0, 1 – 0, 5 мкм. Тонкопленочные маски изготавливают из:
- органических материалов: фото-, электроно-, ионо- и рентгенорезистов, которые могут работать при температуре не выше 423 – 473 К, что определяет критическую плотность мощности ионного тока на мишени: 0, 05 Вт/см2 без охлаждения мишени, 0, 5 Вт/см2 с водяным охлаждением без плотного прижатия к мишени, 1 Вт/см2 с водяным охлаждением по всей площади поверхности мишени;
- металлов: Ti, Cr, Mn, V, Mo, Ta и Al, которые выдерживают температуру 620 – 670 К и скорость травления которых резко уменьшается при напуске кислорода (через такие маски обрабатывают материалы, коэффициент распыления которых мало зависит от парциального давления кислорода: SiO2, Si3N4, Cu, Ag, Au, Pt, GaAs и др.);
- графита, имеющего самый низкий коэффициент распыления в чистом аргоне и выдерживающего большие плотности мощности ионного тока на мишени.
Выбор способа травления заключается в определении приоритетных характеристик: наименьшей селективностью травления и наименьшей погрешностью размеров обработки обладает ионное травление (" ИТ"); наибольшую скорость травления и наименьший нарушенный слой обрабатываемой поверхности можно получить при химическом травлении (" ХТ"); наилучшим сочетанием точности обработки и производительности оборудования обладает ионно-химическое травление (" ИХТ").
Современные методы нанесения тонких пленок распылением мишеней таких твердосмазочных материалов (ТСМ), как дисульфид молибдена позволяют получать покрытия, обладающие уникальными антифрикционными характеристиками при малой толщине и высокой адгезии покрытия к подложке. Интерес к такому покрытию обусловлен низким коэффициентом трения (аномально-низким в условиях сверхвысокого вакуума), малым газовыделением в вакууме, возможностью использования в экстремальных условиях: в вакууме, при высоких температурах и нагрузках.
Основным препятствием к широкому использованию технологий вакуумного нанесения ТСМ в машиностроении является малая, до нескольких микрометров, толщина покрытий, обеспечивающая недостаточно высокую долговечность, несмотря на низкую интенсивность его изнашивания. Поэтому твердосмазочные покрытия (ТСП) толщиной порядка 1 мкм, формируемые вакуумными методами, целесообразно использовать в прецизионных механизмах, а для многоциклических механизмов - необходимо повышать долговечность ТСП.
Одним из возможных решений проблемы является объединение в едином вакуумном цикле операций ионного травления и нанесения тонких пленок с целью формирования на поверхности трения микрорельефа и покрытия, сопоставимых по своей глубине и толщине с параметром шероховатости поверхности. После износа слоя покрытия на участках между микрокарманами антифрикционные свойства контакта обеспечиваются за счет подпитки зоны трения содержащимися в микрокарманах запасами ТСМ.
Использование уникальных возможностей ионных технологий при финишной подготовке поверхности перед нанесением покрытия (ионная очистка и ионная активация) позволяет добиться высокой адгезии тонкой пленки, что приводит к повышению антифрикционных характеристик ТСП. Кроме того, ионно-лучевая обработка может выступать также и в качестве эффективного инструмента для формирования необходимого микрорельефа (микрокарманов), поскольку максимальная требуемая глубина травления составляет до нескольких микрометров. Кроме того, операция ионной полировки поверхности трения, в отличие от традиционной механической обработки, за счет сглаживания вершин микронеровностей обеспечивает наиболее предпочтительный контур шероховатости (с точки зрения уменьшения интенсивности изнашивания тонкопленочного ТСП).
На рис. 28 представлена схема и внешний вид вакуумной установки для формирования в едином вакуумном цикле микрорельефа и ТСП. Ионное травление микрокарманов осуществляется через маску автономным источником ионов, а нанесение ТСП – высокочастотным магнетронным распылительным устройством.
Ионно-лучевая обработка и ионная имплантация
Ионно-лучевая обработка применяется для формирования микрорельефа (рис.29 а), очистки, полировки и активации поверхностей (рис.29 б, в), нанесения тонких пленок в вакууме с ионно-лучевым ассистированием (рис.29 г), распылением (рис.29 д) и осаждением (рис.29 е), а также для модификации и легирования поверхностных слоев деталей с помощью имплантации ионов из сепарированных пучков (Рис.29 ж).
К источникам ионов предъявляются следующие требования: токи пучка ионов должны составлять сотни миллиампер, а плотности тока – несколько мА/см2; энергия ионов должна лежать в диапазоне 0, 05 – 5 кэВ; пучки ионов должны состоять из различных веществ, включая химически активные, например, фтор- и хлорсодержащие соединения, углеводороды, кислород, азот и др.; пучки ионов должны иметь одинаковую плотность тока по сечению пучка большого диаметра, кольцевого, прямоугольного, ленточного, сходящегося или расходящегося. Наиболее полно этим требованиям отвечают источники ионов с холодным катодом, формирующие пучки ионов в скрещенных электрическом и магнитном полях. Источники ионов с горячим катодом практически не пригодны для формирования химически активных пучков ионов.

Разработаны источники ионов с диаметром пучка от 50 до 500 мм, для обработки изделий больших размеров используются прямоугольные пучки с длиной более 1 м. При этом неравномерность обработки, например, толщины наносимой пленки не превышает ±5% при скорости осаждения 1 – 2 нм/с.
В технологии ионной имплантации используются сепарированные моноизотопные пучки ионов (Рис.29 ж). Сравнительно низкая температура обработки материалов, достаточно точный контроль глубины и профиля распределения примеси, возможность автоматизации процесса способствует расширению применения технологии ионной имплантации в различных областях современного производства. В микроэлектронике ионная имплантация применяется при изготовлении полупроводниковых приборов и интегральных микросхем (ИС).
Основными материалами мишени при производстве ИС являются кремний и арсенид галлия, имплантируются фосфор, бор, мышьяк, сурьма и др., а в качестве материала маски используются алюминий, золото, платина, титан, диоксид кремния, нитрид кремния, фоторезисты. Ионная имплантация позволяет управлять дозами облучения от 1010 до 1018 ион/см2 и обеспечивает неоднородность распределения примеси на площади 320 см2 не более 1 - 2 %. С увеличением степени интеграции и рабочей частоты полупроводниковых приборов и ИС уменьшаются как горизонтальные, так и вертикальные размеры элементов. Например, толщина базы и эмиттера в активной области биполярного транзистора могут быть порядка 0, 1 мкм, а геометрические размеры легированной области не превышают 1 – 2 мкм. При изготовлении полевых транзисторов ионной имплантацией получают самосовмещенный затвор (Рис.30), когда полностью совпадают границы областей «исток-затвор» и «сток-затвор», чего нельзя выполнить с помощью высокотемпературной диффузии.

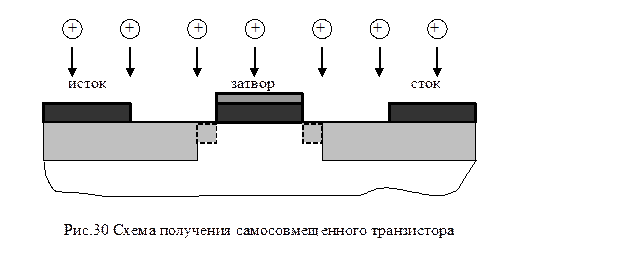
В современной технологии изготовления ИС используются более 10 режимов ионной имплантации (Рис.31). При формировании микроструктур ИС на МОП (металл –оксид - полупроводник) наиболее точным является процесс подлегирования подзатворной области транзистора для регулирования порогового напряжения. При изготовлении биполярных транзисторов наибольшие сложности связаны с формированием субмикронных толщин областей эмиттера и базы транзистора.
В результате бомбардировки поверхности полупроводника и внедрения в его объем ионов примеси в кристалле возникают дефекты, а при больших дозах ионов могут образовываться аморфные участки. Для устранения радиационных дефектов, а также для перемещения электрически неактивных ионов в узлы кристаллической решетки применяется отжиг при температуре 800 – 1200 К.
Уникальная возможность ионной имплантации состоит в легировании материалов атомами отдачи, которые могут получать достаточно высокую энергию от ускоренных ионов и перемещаться на несколько нанометров, что позволяет создавать сверхтонкие легированные слои. Например, если на поверхность кремния нанести тонкую пленку алюминия, а затем бомбардировать ее ионами Si+, Al+ или ионами инертных газов, то атомы алюминия из металлической пленки перемещаются в глубь кремния и образуют слой с максимальной концентрацией атомов у границы кремний-алюминий и спадающей по гиперболе до глубины 5 – 10 нм. При этом удается получить выход атомов отдачи до 10 на один внедренный ион.
Ионная имплантация в металлы и диэлектрики позволяет в широких пределах изменять их свойства. Удается, например, сплавлять металлы, не смешиваемые в жидком состоянии: так, молибден в алюминии практически не растворим, а в результате ионной имплантации в поверхностном слое алюминия образуется сплав, содержащий 25% молибдена. При этом повышается стойкость алюминия к питтинговой коррозии. С помощью ионной имплантации получены пересыщенные твердые растворы, метастабильные интерметаллические соединения, равновесные сплавы и аморфные фазы.
Дозы ионов при имплантации в металлы на 1 – 3 порядка превышают дозы при легировании полупроводниковых материалов и составляют 1016 – 1019 ион/см2. Модификация поверхностных слоев многокомпонентных материалов, таких как стали и сплавы, может быть обусловлена не только имплантацией ионов примеси, но и перераспределением компонентов сплава. Ионной имплантацией можно упрочнять металлы путем изменения структуры поверхности в процессе бомбардировки. При упрочнении металлов (деталей машин, инструмента и т.д.) в их поверхность могут быть имплантированы ионы, играющие роль твердой смазки.
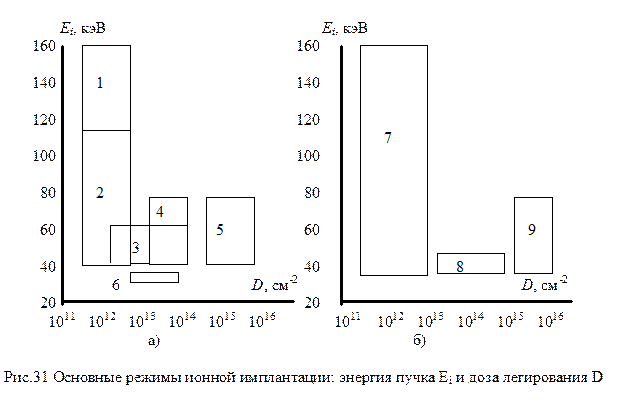
Ионная имплантация в металлы применяется для изменения их поверхностных свойств: увеличения твердости, износостойкости, коррозионной и радиационной стойкости, увеличения сопротивления усталостному разрушению, уменьшения коэффициента трения, управления химическими, оптическими и другими свойствами. Ионная имплантация позволяет упрочнять поверхностные слои металлов и сплавов путем перевода их в аморфное состояние. Аморфизация поверхности различных металлов (Al, Co, Ni, Fe и др.) достигается при имплантации в них ионов металлоидов (B+, P+, As+) или при бомбардировке ионами W+, Ta+, Au+ сталей, в том числе коррозионно-стойких. Для сопротивления изнашиванию наиболее часто используется имплантация ионов N+, B+, C+, Ti+, после чего долговечность деталей или инструмента увеличивается в 2 – 10 раз (Рис.32).

В полимерных материалах ионное легирование позволяет менять электропроводность, которая может возрастать до 14 порядков, структуру и химический состав. Увеличение проводимости связано с перестройкой молекулярной структуры, разрывом связей C-H и появлением избыточного углерода. Имплантируются ионы C+, O+, N+, Ar+ с энергией приблизительно 15 кэВ.
Оборудование ионной имплантации (Рис.33) включает в себя: ионный источник, экстрагирующую и фокусирующую ионную оптику, ускоряющую систему, масс-сепаратор, устройство сканирования ионного пучка, источники питания, приемную камеру, вакуумную систему, устройства контроля и управления технологическим процессом. Оно характеризуется диапазоном энергии ионов от десятков кэВ до нескольких МэВ и плотностью ионного тока от 1010 до 1019 ион/см2.

Атомы имплантированной примеси вводятся в ионный источник либо напуском в виде газа, либо испарением жидкости или твердого вещества. В ионном источнике они ионизируются и вытягиваются электрическим потенциалом в ускоритель, где приобретают нужную энергию. Существует несколько типов источников ионов: с горячим, холодным и полым катодом; дуоплазмотроны; источники с ВЧ и СВЧ возбуждением; с поверхностной ионизацией. Для получения многозарядных (двух или трехзарядных) ионов используются дуговой источник с катодом косвенного накала.
Ускоритель ионов предназначен для сообщения ионам необходимой плотности энергии и фокусировки пучка при его движении вдоль ускорителя. Он может располагаться до или после масс-сепаратора. Масс-сепаратор применяется для отделения имплантируемых ионов от других веществ, присутствующих при формировании пучка в источнике ионов, т.е. для создания моноизотопного пучка ионов. Принцип его действия основан на различии радиуса R отклонения ускоренных электрическим потенциалом U ионов с разной массой m и зарядом zq в магнитном поле B

 .
.
Устройство сканирования ионного пучка направляет сфокусированный ионный луч в нужное место мишени по заданной программе. В оборудовании ионной имплантации применяются три способа сканирования: механическое, электростатическое и комбинированное. При механическом сканировании ионный луч не перемещается в перпендикулярных его движению направлениях, а перемещается мишень относительно луча в двух взаимно перпендикулярных направлениях. При электростатическом сканировании ускоренный потенциалом U ионный луч отклоняется от направления своего движения потенциалом Ur отклоняющих электродов длиной l и расстоянием между ними d на угол Q
 .
.
Отклонение ионного луча на поверхности мишени равно Dy= L tgQ, где L – расстояние от отклоняющей системы до мишени. Система сканирования должна обеспечивать однородность легирования поверхности, поэтому необходимо учитывать наклон мишени к направлению движения ионного пучка, неравномерность скорости сканирования луча при различных углах Q, диаметр или стороны сечения ионного пучка, неравномерность плотности ионного тока по сечению пучка.
Приемная камера служит для загрузки, фиксации, перемещения во время легирования и выгрузки обрабатываемых изделий. Вакуумные системы оборудования ионной имплантации строятся как на масляных (с использованием диффузионных насосов), так и на безмасляных вакуумных насосах (турбомолекулярных или криогенных).
|
|