
Главная страница Случайная страница
Разделы сайта
АвтомобилиАстрономияБиологияГеографияДом и садДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеталлургияМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРелигияРиторикаСоциологияСпортСтроительствоТехнологияТуризмФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
IGBT-модули
|
|
Рисунок 1 — Условное обозначение IGBT
Коммерческое использование IGBT началось с 80-х годов и уже претерпела четыре стадии своего развития.
I поколение IGBT (1985 г.): предельные коммутируемые напряжения 1000 В и токи 200 А в модульном и 25 А в дискретном исполнении, прямые падения напряжения в открытом состоянии 3, 0-3, 5 В, частоты коммутации до 5 кГц (время включения/выключения около 1 мкс).
II поколение (1991 г.): коммутируемые напряжения до 1600 В, токи до 500 А в модульном и 50 А в дискретном исполнении; прямое падение напряжения 2, 5-3, 0 В, частота коммутации до 20 кГц (время включения/ выключения около 0, 5 мкс).
III поколение (1994 г.): коммутируемое напряжение до 3500 В, токи 1200 А в модульном исполнении. Для приборов с напряжением до 1800 В и токов до 600 А прямое падение напряжения составляет 1, 5-2, 2 В, частоты коммутации до 50 кГц (времена около 200 нс).
IV поколение (1998 г.): коммутируемое напряжение до 4500 В, токи до 1800 А в модульном исполнении; прямое падение напряжения 1, 0-1, 5 В, частота коммутации до 50 кГц (времена около 200 нс).
IGBT являются продуктом развития технологии силовых транзисторов со структурой металл-оксид-полупроводник, управляемых электрическим полем (MOSFET- Metal-Oxid-Semiconductor-Field-Effect-Transistor) и сочетают в себе два транзистора в одной полупроводниковой структуре: биполярный (образующий силовой канал) и полевой (образующий канал управления). Эквивалентная схема включения двух транзисторов приведена на рисунке 2. Прибор введён в силовую цепь выводами биполярного транзистора E (эмиттер) и C (коллектор), а в цепь управления - выводом G (затвор).

Рисунок 2 — Схема соединения транзисторов в единой структуре IGBT
Таким образом, IGBT имеет три внешних вывода: эмиттер, коллектор, затвор. Соединения эмиттера и стока (D), базы и истока (S) являются внутренними. Сочетание двух приборов в одной структуре позволило объединить достоинства полевых и биполярных транзисторов: высокое входное сопротивление с высокой токовой нагрузкой и малым сопротивлением во включённом состоянии.
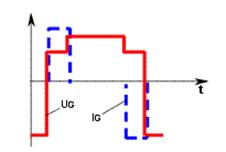
Рисунок 3 — Диаграмма напряжения и тока управления
Схематичный разрез структуры IGBT показан на рисунке 4, а. Биполярный транзистор образован слоями p+ (эмиттер), n (база), p (коллектор); полевой - слоями n (исток), n+ (сток) и металлической пластиной (затвор). Слои p+ и p имеют внешние выводы, включаемые в силовую цепь. Затвор имеет вывод, включаемый в цепь управления. На рисунке 4, б изображена структура IGBT IV поколения, выполненого по технологии " утопленного" канала (trench-gate technology), позволяющей исключить сопротивление между p-базами и уменьшить размеры прибора в несколько раз.
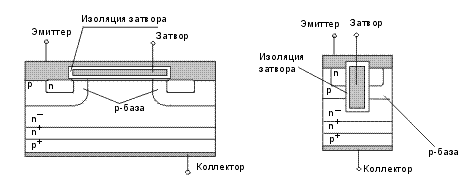
Рисунок 4 — Схематичный разрез структуры IGBT: а-обычного (планарного); б-выполненого по " trench-gate technology"
Процесс включения IGBT можно разделить на два этапа: после подачи положительного напряжения между затвором и истоком происходит открытие полевого транзистора (формируется n - канал между истоком и стоком). Движение зарядов из области n в область p приводит к открытию биполярного транзистора и возникновению тока от эмиттера к коллектору. Таким образом, полевой транзистор управляет работой биполярного.
Для IGBT с номинальным напряжением в диапазоне 600-1200 В в полностью включённом состоянии прямое падение напряжения, так же как и для биполярных транзисторов, находится в диапазоне 1, 5-3, 5 В. Это значительно меньше, чем характерное падение напряжения на силовых MOSFET в проводящем состоянии с такими же номинальными напряжениями.
С другой стороны, MOSFET c номинальными напряжениями 200 В и меньше имеют более низкое значение напряжения во включённом состоянии, чем IGBT, и остаются непревзойдёнными в этом отношении в области низких рабочих напряжений и коммутируемых токов до 50 А.
По быстродействию IGBT уступают MOSFET, но значительно превосходят биполярные. Типичные значения времени рассасывания накопленного заряда и спадания тока при выключении IGBT находятся в диапазонах 0, 2-0, 4 и 0, 2-1, 5 мкс, соответственно.
Область безопасной работы IGBT позволяет успешно обеспечить его надёжную работу без применения дополнительных цепей формирования траектории переключения при частотах от 10 до 20 кГц для модулей с номинальными токами в несколько сотен ампер. Такими качествами не обладают биполярные транзисторы, соединённые по схеме Дарлингтона.
Так же как и дискретные, MOSFET вытеснили биполярные в ключевых источниках питания с напряжением до 500 В, так и дискретные IGBT делают то же самое в источниках с более высокими напряжениями (до 3500 В).
IGBT-модули
В настоящее время транзисторы IGBT выпускаются, как правило, в виде модулей в прямоугольных корпусах с односторонним прижимом и охлаждением (" Mitsubishi", " Siemens", " Semikron" и др.) и таблеточном исполнении с двухсторонним охлаждением (" Toshiba Semiconductor Group"). Модули с односторонним охлаждением выполняются в прочном пластмассовом корпусе с паяными контактами и изолированным основанием. Все электрические контакты находятся в верхней части корпуса. Отвод тепла осуществляется через основание. Типовая конструкция модуля в прямоугольном корпусе показана на рисунке 5.

Рисунок 5 — Типовая конструкция IGBT-модуля: 1 - кристалл; 2 - слой керамики; 3 - спайка; 4 - нижнее тепловыводящее основание
Ток управления IGBT мал, поэтому цепь управления - драйвер конструктивно компактна. Наиболее целесообразно располагать цепи драйвера в непосредственной близости от силового ключа. В модулях IGBT драйверы непосредственно включены в их структуру. " Интеллектуальные" транзисторные модули (ИТМ), выполненные на IGBT, также содержат " интеллектуальные" устройства защиты от токов короткого замыкания, системы диагностирования, обеспечивающие защиту от исчезновения управляющего сигнала, одновременной проводимости в противоположных плечах силовой схемы, исчезновения напряжения источника питания и других аварийных явлений. В структуре ИТМ на IGBT предусматривается в ряде случаев система управления с широтно-импульсной модуляцией (ШИМ) и однокристальная ЭВМ. Во многих модулях имеется схема активного фильтра для коррекции коэффициента мощности и уменьшения содержания высших гармонических в питающей сети.
IGBT-модуль по внутренней электрической схеме может представлять собой единичный IGBT, двойной модуль (half-bridge), где два IGBT соединены последовательно (полумост), прерыватель (chopper), в котором единичный IGBT последовательно соединён с диодом, однофазный или трёхфазный мост. Во всех случаях, кроме прерывателя, модуль содержит параллельно каждому IGBT встроенный обратный диод. Наиболее распространённые схемы соединений IGBT- модулей приведены на рисунке 6.

Рисунок 6 — Схемы IGBT-модулей
Интенсивно развивается технология корпусирования паяной конструкции силовых модулей с целью дальнейшего снижения габаритов и массы, повышения надёжности, энерго- и термоциклоустойчивости, уменьшения теплового сопротивления и стоимости. Эти цели достигаются применением новых материалов и технологий сборки на тонкие и AlN керамические подложки в корпусах с малоиндуктивными выводами, разработкой специальных конструкций силовых модулей с интегрированным жидкостным охлаждением и созданием силовых модулей, включая " интеллектуальные", с использованием матричных композиционных материалов, имеющих хорошие теплопроводящие свойства и низкие, согласованные с кремнием и керамикой, коэффициенты теплового расширения (КТР).
В модулях с интегральным жидкостным охлаждением почти в четыре раза удаётся увеличить отводимую рассеиваемую мощность по сравнению с сопоставимой по электрическим параметрам традиционной конструкцией силового модуля с воздушным охлаждением.
Применение матричных композиционных материалов (MMC- Metal Matrix Composite) открывает новые перспективы в создании высокомощных, компактных, прочных, надёжных силовых модулей. MMC имеют высокую теплопроводность (MMC-150 Вт/(м*К), Cu-370, Al-200, Si-80), низкий КТР (MMC-7, Cu-17, Al-23, Si-4, -7, AlN-7), что позволяет снизить до минимума напряжённости в конструкции модуля, особенно в чипах силовых приборов, обеспечивая хорошую электрическую изоляцию и эффективный отвод тепла. В настоящее время по этой концепции созданы " интелектуальные" силовые модули (выпрямитель-инвертор) мощностью до 100 кВт.
Наряду с развитием технологии паяной конструкции силовых модулей с изолированным основанием (предельные параметры 1, 2 кА, 3, 5 кВ) продолжает интенсивно развиваться технология прижимной конструкции IGBT- модулей, подобная таблеточной конструкции SCR (Silicon Controlled Rectifier) и GTO - press-pack technology, в которой наряду с уменьшением более чем в 10 раз теплового сопротивления и габаритов значительно улучшены надёжность, термоциклоустойчивость. Наиболее высоких параметров IGBT- модулей прижимной конструкции достигла кампания " Toshiba" (PP HV IGBT-press pack high voltage IGBT).
|
|