
Главная страница Случайная страница
Разделы сайта
АвтомобилиАстрономияБиологияГеографияДом и садДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеталлургияМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРелигияРиторикаСоциологияСпортСтроительствоТехнологияТуризмФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Выделение периодических наноструктур на фоне шумов
|
|
при просвечивающей электронной микроскопии [15, 16]
Современная просвечивающая электронная микроскопия обеспечивает возможность получения информации об объекте как в прямом, так и в обратном пространствах. Наряду с зондовыми электронно-микроскопическими методами, она позволяет визуализировать и исследовать наноразмерные области и, обладая разрешением вплоть до атомарного, проводить детальный анализ атомных расположений. Используя плоскопараллельное освещение или
сходящиеся электронные пучки при получении
дифракционных картин, в электронном микро-
скопе можно изучать угловые распределения
рассеянных в образце электронов, что сближает
просвечивающую микроскопию с методом рент-
геноструктурного анализа.
Помимо структурных исследований, просве-
чивающая электронная микроскопия позволяет
определять химический состав образца, исполь-
зуя методы рентгеноспектрального анализа и
спектроскопию энергетических потерь быстрых
электронов.Достигаемое пространственное раз-
решение может быть лучше 1 нм, что дает
возможность непосредственного определения
элементного состава как нанообразований в
материалах, так и отдельных наночастиц.
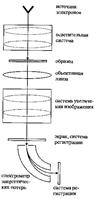 Схема просвечивающего электронного микро-
Схема просвечивающего электронного микро-
скопа показана на рис. 3.14.
В качестве источника электронов в
электронной пушке, создающей пучок с
энергией, превышающей 100 кэВ, используются
катоды, изготовленные из вольфрама или
Рис. 3.14. Схема просвечивающего гексоборида лантана (LaB6) и испускающие
электронного микроскопа
электроны вследствие явления термоэлектронной эмиссии. Катоды из LaB6 по сравнению с катодами из W обеспечивают более высокий ток пучка и меньший разброс в энергии вылетающих из пушки электронов. Однако еще меньший энергетический разброс, большую плотность тока и высокую когерентность электронного пучка позволяют получить источники с полевой эмиссией электронов.
Осветительная система микроскопа включает две, иногда три линзы и позволяет варьировать освещение образца в широких пределах – от широкого, почти параллельного падающего пучка до сфокусированного электронного зонда с поперечными размерами менее одного нанометра.
Столик и держатели образца в современном электронном микроскопе позволяют не только менять ориентацию исследуемого объекта относительно электронного пучка, но и проводить наблюдения изменений структуры образца, вызываемых его нагревом или охлаждением, приложением механических напряжений и т.д.
Объективная линза является одной из основных линз оптической системы микроскопа. Она определяет предел разрешения получаемых электронно-микроскопических изображений. Система увеличения микроскопа состоит из блоков промежуточных и проекционных линз, обеспечивающих вместе с объективной линзой возможность получения изображений с коэффициентом увеличения до 1, 5·10 6 раз.
Получаемые в электронном микроскопе изображения и дифракционные картины могут визуально наблюдаться на флуоресцентном экране и регистрироваться на фотопленку или фотопластины. В последнее время все чаще используют электронную систему записи получаемой информации, основанную на использовании ПЗС-матриц (ПЗС — приборы с зарядовой связью). Эти системы обеспечивают запись электронно-микроскопических изображений и дифракционных картин в оцифрованном виде, что позволяет проводить их последующую математическую обработку на ЭВМ.
Высокоразрешающие электронно-микроскопические изображения, получа-емые на современных микроскопах, позволяют выявлять детали структуры с разрешением лучше 0, 2 нм и приближающимся к 0, 1 нм на уникальных приборах. Вместе с тем получение количественной структурной информации на их основе является непростой задачей. В процессе обработки и получения экспериментальных микроизображений необходимо устранить такие нежелательные эффекты, как неравномерный уровень фона и шум.
Процедура устранения шумов играет особо важную роль в случае обработки высокоразрешаюших микроизображений. При этом наиболее значимые шумы на них обусловлены небольшими нерегулярностями приготовленного образца, в частности, из-за образования на поверхности образца аморфного слоя толщиной в несколько нанометров. Соотношение между толщиной аморфного слоя и размерами кристаллической части образца меняется от одного локального участка к другому, что приводит к флуктуациям электронно-микроскопического контраста.
Загрязнения и радиационные нарушения, вызываемые высокоэнергич-ными электронами в процессе наблюдения в электронном микроскопе, представляют собой другой источник изменения контраста изображения. Радиационные нарушения могут приводить к образованию дефектов внутри тонкой фольги и как следствие изменять структуру образца, что затрудняет интерпретацию соответствующих высоко разрешающих изображений. Шумы такого рода проявляются локально и зависят от выбранной области образца.
Различные виды шумов часто бывает трудно отделить друг от друга. Например, частично аморфизированный материал может давать приблизи-тельно такой же вклад в изображение, как и деформированный кристаллический участок образца.
Еще одним видом шума является так называемый квантовый шум (см. п. 2.3.7).Он порождает значительные вариации интенсивности в сильно локализованных участках изображения образца (порядка 1/10 межатомного расстояния). Интенсивность при этом может меняться больше чем на порядок по сравнению с её средним значением. Данный вид шума устраняется с помощью применения специальных фильтров в процессе цифровой обработки изображений.
Одним из наиболее эффективных способов устранения шума в прямом пространстве является метод, основанный на усреднении периодического мотива изображения, характерного для высокоразрешающих микрофотографий кристаллических образцов. Применение кросс-корреляционной функции позволяет точно установить позиции фрагментов изображения с идентичным мотивом. Получаемая величина ошибки в распределении интенсивности на усредненном изображении пропорциональна 1/  , где N — число фрагментов изображения, используемых для усреднения. Хотя эта процедура хорошо отработана для кристаллических образцов, она не может быть непосредственно применена в случае границ между кристаллом и аморфным материалом, поскольку точные позиции атомов в аморфном веществе неизвестны. Однако если граница является плоской, то структура аморфного приграничного слоя может быть установлена на основе усреднения высокоразрешающих изображений.
, где N — число фрагментов изображения, используемых для усреднения. Хотя эта процедура хорошо отработана для кристаллических образцов, она не может быть непосредственно применена в случае границ между кристаллом и аморфным материалом, поскольку точные позиции атомов в аморфном веществе неизвестны. Однако если граница является плоской, то структура аморфного приграничного слоя может быть установлена на основе усреднения высокоразрешающих изображений.
Отметим, что данный способ выделения периодических микро- и нано- структур сильно напоминает задачу об обнаружении слабых сигналов на фоне шумов, рассмотренную нами в п. 3.1.5.
|
|