
Главная страница Случайная страница
Разделы сайта
АвтомобилиАстрономияБиологияГеографияДом и садДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеталлургияМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРелигияРиторикаСоциологияСпортСтроительствоТехнологияТуризмФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Пассивные элементы интегральных микросхем
|
|
Усложнение электронных устройств и систем, в которых количество дискретных элементов достигло десятков и сотен тысяч, вызвало снижение эксплуатационной надежности при одновременном увеличении габаритов и массы, росте потребления электрической энергии, стоимости. Эти недостатки устраняются с внедрением изделий микроэлектроники.
Микроэлектроника – это область науки и техники, занимающаяся физическими и техническими проблемами создания интегральных схем. Интегральная технология является наиболее важным технологическим приемом микроэлектроники и позволяет на одной пластине создавать группы элементов, схемно соединенных между собой. Функциональные узлы, выполненные по интегральной технологии, называют интегральными микросхемами.
Интегральная микросхема – это микроэлектронное изделие, выполняющее определенную функцию преобразования, имеющее высокую плотность упаковки электрически соединенных компонентов (транзисторов, резисторов и др.), изготовленных в едином технологическом цикле на общей подложке.
Наиболее распространенными пассивными элементами в полупроводниковых микросхемах являются резисторы. Слой полупроводника, изолированный от других элементов, может служить резистором интегральной микросхемы. Однако, ввиду низкого удельного сопротивления слоя полупроводника, резисторы занимают большую часть площади всей микросхемы. В связи с этим микросхемы проектируют с минимальным числом резисторов, а величина их сопротивления должна быть небольшой, менее 10 кОм. Так, к примеру, цифровые интегральные микросхемы содержат меньше резисторов, чем аналоговые схемы. А цифровые микросхемы на полевых транзисторах практически не имеют резисторов, их функции выполняют дополнительные транзисторы, работающие на крутом восходящем участке вольт-амперной характеристики.
Наряду с резисторами в гибридных интегральных микросхемах распространенными пассивными элементами являются пленочные конденсаторы. При этом пассивные элементы во многом определяют схемотехнические и эксплуатационные характеристики интегральных микросхем (ИМС). В низкочастотных микросхемах используются дискретные миниатюрные конденсаторы и катушки индуктивности, а в аналоговых высокочастотных микросхемах – пленочные конденсаторы емкостью менее 100 пФ. Пленочные конденсаторы бывают как тонко-, так и толстопленочные и занимают большую площадь ИМС. В связи с этим в полупроводниковых интегральных микросхемах роль конденсаторов выполняют обратносмещенные p–n переходы и структуры металл-диэлектрик-полупроводник (МДП-конденсаторы).
Несмотря на ограничения на геометрические размеры и наминалы или допуски абсолютных значений, пассивные элементы в интегральных схемах обладают некоторыми преимуществами монолитных структур, такими, как хорошая воспроизводимость по номинальной величине и температурной зависимости.
В зависимости от формы обрабатываемых электрических сигналов микросхемы бывают аналоговыми или цифровыми.
Параметром, определяющим уровень сложности микросхем, является степень интеграции, под которой понимается округленный до ближайшего целого числа коэффициент К, являющийся показателем десятичного логарифма от числа N содержащихся в микросхеме элементов и компонентов:  .
.
По уровню сложности цифровые микросхемы подразделяются на малые (МИС, К £ 1…2), средние (СИС, 2 £ К £ 3…4), большие (БИС, 3…4 £ К £ 5) и сверхбольшие (СБИС, K > 5).
Основные типы микросхем – пленочные и полупроводниковые. В пленочных микросхемах элементы и соединения выполнены в виде различных пленок (проводящие, резистивные и диэлектрические) на подложке из диэлектрика. В полупроводниковых микросхемах пассивные и активные элементы вместе с изолирующими и проводящими областями создаются на одной подложке кремния или другого полупроводника. Применяются еще и так называемые гибридные микросхемы, в которых органически сочетаются в одном корпусе пленочные конструкции из пассивных элементов с дискретными миниатюрными активными компонентами.
К пассивным компонентам ИС относятся резисторы, конденсаторы, индуктивности и внутрисхемные соединения.
В ИМС применяются пленочные, диффузионные резисторы и резисторы на основе МДП-структур.
Сопротивление бруска из однородного проводящего кристаллического материала определяется выражением
 , (7.1)
, (7.1)
где r – удельное сопротивление резистивного материала, величина обратная удельной проводимости
 , (7.2)
, (7.2)
l, b, d – длина, ширина и толщина резистивной пленки.
Для изготовления пленочных резисторов используются различные материалы: металлы, сплавы, смеси металлов с диэлектриком (керметы), удовлетворяющие требованиям по металлургической совместимости, адгезии, технологичности и стабильности. Каждый материал характеризуется определенной толщиной, для которой удельное сопротивление материала является оптимальным  .
.
Этот параметр rs называют поверхностным сопротивлением, которое имеет размерность Ом, но часто выражается в Омах на квадрат (Ом/ð). А сопротивление резистора
 . (7.3)
. (7.3)
Резисторы в тонкопленочных ИС представляют собой или полоску, или пленку определенной конфигурации, нанесенную между двумя контактами на изолирующей подложке. На рис. 7.1, а, б показаны конфигурации пленочных резисторов.

Ри.7.1. Упрощенная конструкция пленочных резисторов (а, б), структурная и эквивалентная схема.
Используя поверхностное сопротивление rs в качестве параметра резистивной пленки, можно изготавливать резисторы с различными сопротивлениями, используя один и тот же материал, изменяя только отношение l/b. Для прямоугольных резисторов максимальная длина по технологическим соображениям ограничена величиной  . Для реализации резисторов с Kф> 10 используют зигзагообразную конфигурацию рис. 6.1, б, при этом площадь платы, занимаемая резистором, уменьшается. Сопротивление пленочного резистора может достигать значений порядка 10 МОм. После нанесения резистивной пленки обычно производится подгонка резистора под номинал, что позволяет получить прецизионные и стабильные резисторы.
. Для реализации резисторов с Kф> 10 используют зигзагообразную конфигурацию рис. 6.1, б, при этом площадь платы, занимаемая резистором, уменьшается. Сопротивление пленочного резистора может достигать значений порядка 10 МОм. После нанесения резистивной пленки обычно производится подгонка резистора под номинал, что позволяет получить прецизионные и стабильные резисторы.
В монолитных ИМС используются диффузионные резисторы, изготавливаемые одновременно с транзисторами в одном технологическом процессе и на той же подложке. Диффузионные резисторы изготавливаются на диффузионных слоях базовой и эмиттерной областей транзисторной структуры (рис. 6.1, в).
Эмиттерная область содержит наибольшую концентрацию примеси и имеет наименьшее удельное сопротивление. Эмиттерная область служит для создания резисторов с малым сопротивлением до 10 Ом и малым температурным коэффициентом сопротивления: ТКС = 0, 01 %/°С.
Коллекторная область транзистора содержит наименьшую концентрацию примеси и обладает большим сопротивлением. Из-за малой концентрации примеси температурный коэффициент сопротивления у этих резисторов очень велик.
На практике в качестве диффузионного резистора используется базовая область транзисторной структуры, сопротивление которой может достигать 50 кОм с ТКС = 0, 1…0, 3 %/°С.
Для получения резисторов с большими номиналами сопротивлений используются так называемые пинч-резисторы (сжатый резистор), которые изготавливаются в процессе базовой диффузии в виде резистивных слоев. Пинч-резистор имеет меньшую площадь сечения, ограниченную p–n переходом, образованного путем эмиттерной диффузии на поверхности резистивного слоя. Это позволяет увеличивать поверхностное сопротивление и изготавливать резисторы большого номинала на малой площади.
Эквивалентная схема диффузионного резистора (рис. 6.1, г) достаточно сложная и содержит следующие основные и паразитные элементы:
R1 – сопротивление проводящего слоя резистора; R2 – сопротивление токам утечки n–области; R3 –сопротивление контактов и подводящих электродов (порядка 10 Ом); R4 – сопротивление токам утечки подложки; C1 – емкость верхнего p–n перехода; C2 – емкость нижнего p–n перехода; T – паразитный транзистор, у которого коллекторный переход образован подложкой и эпитаксиальной пленкой, а эмиттерный – слоем резистора и эпитаксиальной пленкой. Величины емкостей C1 и C2 невелики и оказывают влияние на высоких частотах. Для каждого резистора имеется своя частота, выше которой начинается резкое уменьшение сопротивления. На практике она составляет около 10 ГГц.
В микросхемах на МДП-транзисторах в качестве резисторов в виде нагрузочного сопротивления используются транзисторы, работающие на квазилинейном участке ВАХ. Сопротивление нагрузочного резистора зависит от смещения на затворе и от разности потенциалов между истоком и подложкой. При изменении потенциала истока происходит модуляция проводимости канала под действием нижнего затвора, что приводит к изменению сопротивления нагрузочного резистора.
Диффузионные резисторы характеризуются, как и другие резистивные элементы, следующими параметрами: диапазоном номинальных значений сопротивлений, допуском по сопротивлению, температурным коэффициентом сопротивления, допустимой мощностью рассеяния и максимальным напряжением.
Из рассмотренного видно, что имеются возможности создавать резисторы больших номиналов. Однако в ИС для уменьшения габаритных размеров стремятся использовать минимальное число резисторов с максимальными номиналами.
Другими пассивными элементами интегральных микросхем являются конденсаторы. В интегральных полупроводниковых схемах обычно применяют конденсаторы на основе p–n переходов и на основе структуры металл–диэлектрик–полупроводник. В интегральных схемах, использующих биполярные транзисторы, роль конденсаторов выполняют p–n переходы. При формировании p–n переходов используется диффузия, поэтому конденсаторы на их основе называют диффузионными. Структура такого конденсатора показана на рис. 7.2, цифрами 1 и 2 обозначены омические контакты. Принцип работы диффузионных конденсаторов основан на использовании барьерной емкости обратносмещенного p–n перехода, где диэлектриком служит обедненный слой p–n перехода.

Рис 7.2 Структурная схема интегрального конденсатора на основе p-n перехода.
Наибольшую удельную барьерную емкость C0 имеет переход эмиттер-база. Однако он обладает низким пробивным напряжением Uпр эб £ 10 В, что ограничивает его применение. Поэтому широко используется конденсатор, образованный переходом база–коллектор, имеющий высокое пробивное напряжение.
Эквивалентная схема конденсатора на основе коллекторного p–n перехода представлена на рис. 6.3, где C1 – барьерная емкость коллекторного перехода; C2 – паразитная емкость изолирующего перехода коллектор–подложка. Она имеет ограниченное применение, так как вывод подложки является общим для всей ИС и заземлен по переменной составляющей тока. Конденсатор C2 однако является неотъемлемой частью интегральной схемы, так как он всегда имеется при изоляции элементов схемы
p-n переходом. Диоды D1 и D2 образуют емкости C1 и C2. R – сопротивление, характеризующее неидеальность диэлектрика и наличие объемного сопротивления у p–слоя.
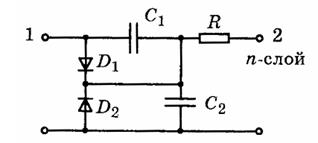
Рис7.3 Эквивалентная схема интегрального конденсатора на основе p-n перехода.
Для эффективного использования конденсатора, т.е. для получения максимального коэффициента передачи сигнала через конденсатор в нагрузку, необходимо, чтобы отношение C1/C2 было возможно больше. Это достигается при низком обратном смещении перехода база–коллектор и при большом напряжении смещения перехода коллектор–подложка, что позволяет получить С1/С2 в пределах от 3 до 10. Приближенное значение максимальной емкости диффузионного конденсатора составляет 500 пФ. Максимальное допустимое рабочее напряжение лежит в пределах от –15 до –25 В.
Сопротивление R влияет на добротность конденсатора, которая определяется соотношением
 . (7.4)
. (7.4)
При увеличении сопротивления этого или любого резистора, включенного последовательно с конденсатором, добротность его уменьшается.
Такой конденсатор является полярным. Его емкость изменяется в зависимости от значения приложенного напряжения. Максимальное значение емкости конденсатора тогда, когда напряжение внешнего смещения равно нулю. Емкость определяется контактной разностью потенциалов. Однако такой режим работы конденсатора на практике используется редко. Как исключение иногда используется режим малых напряжений, но при этом переход должен быть обратно смещен при любой фазе приложенных напряжений. Кремниевый переход находится в закрытом состоянии до напряжения Uпр = 0, 5…0, 7 В, приложенного в прямом направлении. Поэтому при изменении ширины объемного заряда p–n перехода под действием приложенного напряжения изменяется (модулируется) емкость конденсатора. Для уменьшения эффекта модуляции емкости конденсатора напряжение смещения должно быть больше амплитуды переменного напряжения, приложенного к переходу.
Конденсаторы, использующие свойства p–n перехода, имеют ряд недостатков:
– небольшие номинальные значения емкости,
– малая добротность,
– зависимость емкости от приложенного напряжения. На низких частотах влияние оказывает обратное сопротивление p–n перехода, а на высоких частотах сопротивление обкладок больше, чем структуры.
Эти недостатки можно устранить используя МДП-конденсаторы. В качестве диэлектрика используется слой двуокиси кремния, на который в дальнейшем наносится пленка алюминия, являющаяся обкладкой конденсатора. Второй обкладкой является сильнолегированная область кремния n+, имеющая омический контакт с выводом.
У МДП-конденсаторов имеется один p–n переход между коллекторной областью транзисторной структуры и подложкой, служащей для изоляции МДП-конденсатора от других элементов, расположенных на подложке.
Эквивалентная схема такого конденсатора включает Сs – поверхностная емкость полупроводника, определяемая поверхностным состоянием полупроводника, его способностью отдавать в объем полупроводника электроны и захватывать дырки, или отдавать дырки, а захватывать электроны. На поверхности полупроводника возникает положительный или отрицательный заряды. C – полезная емкость, удельная емкость которой при толщине диэлектрического слоя 0, 08…0, 1 мкм составляет величину порядка 400…650 пФ/м2. R – сопротивление n+–слоя и омических контактов. D – диод, образованный p–n переходом. C1 – емкость диода.
МДП-конденсаторы являются неполярными и работают при любой полярности напряжения. Это является важным преимуществом МДП-конденсаторов перед диффузионными. Кроме того емкость МДП-конденсаторов зависит от частоты, а коэффициент передачи составляет не менее 0, 9. В связи с этим МДП-конденсаторы не пригодны для работы в СВЧ диапазоне.
Пленочные конденсаторы позволяют получить большую емкость и представляют собой многослойную структуру, показанную на рис. 6.6. На подложку наносится слой металла, служащий обкладкой конденсатора, на поверхности которого наносится слой диэлектрика. Диэлектрик покрывается металлическим слоем, служащим второй обкладкой конденсатора. В качестве диэлектрика используется оксид тантала или монооксид кремния. Температурный коэффициент емкости таких конденсаторов порядка 0, 02…0, 04 %/°С, а добротность на высоких частотах определяется сопротивлением обкладок. В связи с этим чаще используются алюминиевые обкладки. Сопротивление пленки тантала велико, поэтому танталовые конденсаторы являются низкочастотными.
В отличие от конденсаторов на основе p–n перехода в тонкопленочных конденсаторах параметры не зависят от величины и полярности прикладываемого напряжения и имеют большее значение емкости на единицу площади при меньшем паразитном воздействии. Однако имеется два основных недостатка, присущих тонкопленочным конденсаторам: требуются дополнительные технологические этапы, помимо обычных диффузионных циклов; выходят из строя из-за пробоя диэлектрика, когда напряжение превышает номинальное значение.
Основным и наиболее универсальным элементом интегральных микросхем является биполярный транзистор. В большинстве случаев используется транзистор n–p–n типа, ибо подвижность электронов больше подвижности дырок, и они обладают лучшими частотными свойствами, чем транзисторы p–n–р типа.
Главное отличие структур биполярных транзисторов в микросхемах от дискретных транзисторов состоит в том, что интегральные транзисторы имеют дополнительные области, которые изолируют транзисторы от общей полупроводниковой подложки. Все выводы интегральных транзисторов располагаются на одной плоскости, что позволяет легко проводить межэлементные соединения всей микросхемы.
Изготовление транзисторов осуществляется одновременно с созданием других элементов схемы: резисторов, конденсаторов, диодов; при этом используются аналогичные полупроводниковые области: эмиттерная, базовая, коллекторная, т.е. все элементы полупроводниковых микросхем конструктивно и технологически совместимы.
Структура планарно-эпитаксиального транзистора представлена на рис. 7.7. На кремниевой подложке с электропроводностью р–типа методом диффузии изготавливаются области коллектора, базы и эмиттера. Особенностью планарных транзисторов является неравномерное распределение примеси в коллекторной области.

Рис 7.7 структурная схема планарно-эпитаксиального транзистора
Наличие большого числа примеси у коллекторного перехода обуславливает низкое значение пробивного напряжения коллекторного перехода и большое значение обратного сопротивления коллектора. Все это вызывает сильное влияние подложки на электрические параметры транзистора и ограничивает возможности планарных транзисторов в полупроводниковых интегральных схемах.
Улучшить ряд параметров транзисторов удается используя планарно-эпитаксиальную технологию. Важной конструктивной особенностью эпитаксиально-планарных транзисторов является скрытый n+–слой, предназначенный для уменьшения объемного сопротивления коллекторной области и уменьшения степени влияния подложки на характеристики и параметры транзисторов. Низкоомный скрытый слой шунтирует расположенный над ним более высокоомный коллекторный слой n–типа и в десятки раз уменьшает объемное сопротивление коллекторной области между коллекторным переходом и выводом коллектора.
Выходные характеристики в схеме с общим эмиттером в диапазоне малых значений Uкэ для транзисторов без скрытого слоя 1 и со скрытым слоем 2 приведены на рис. 7.8. Скрытый n+–слой влияет на форму выходной характеристики только в режиме насыщения, где rк диф невелико. Скрытый слой позволяет получить малое значение остаточного напряжения при работе транзистора в цифровых микросхемах.
Интегральные транзисторы в полупроводниковых микросхемах обладают следующими параметрами: коэффициент передачи тока базы порядка 200; граничная частота до 500 МГц; емкость коллектора до 0, 5 пФ; пробивное напряжение для коллекторного перехода до 50 В, для эмиттерного до 8 В; удельное сопротивление n– и p–слоев составляет несколько сотен, а n+–слоя – не более 20 Ом/ð.
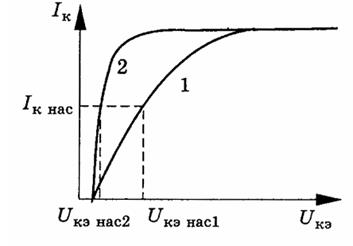
Рис 7.7 Вольт-амперные характристики планарно-эпитаксиального транзистора: без скрытого (1) и со скрытым слоями(2)
Ввиду того, что интегральный транзистор занимает малую площадь подложки по сравнению с пассивными элементами, то в интегральных микросхемах используется большее число транзисторов, чем в дискретных аналогах.
Некоторые аналоговые схемы требуют использования p–n–р транзисторов, которые изготавливаются одновременно с транзисторами n–p–n типа. Такой интегральный транзистор принято называть горизонтальным, боковым или латеральным (рис. 7.9).

Рис.7.9. Структурная схема интегрального горизонтального транзистора
Эмиттерный и коллекторный переходы изготавливаются одновременно за счет диффузии акцепторной примеси. За счет меньшей подвижности дырок коэффициент передачи тока базы и граничная частота усиления значительно ниже, чем у аналогичных n–p–n транзисторов.
В латеральном транзисторе перенос зарядов протекает в горизонтальном направлении, параллельно поверхности подложки. Инжектированные эмиттером дырки диффундируют в горизонтальном направлении к коллектору. Коэффициент усиления по току латерального транзистора невелик из-за малого коэффициента инжекции эмиттера и широкой базы. Относительно низкая концентрация примесей и небольшая эффективная площадь эмиттера не позволяют получить большой коэффициент инжекции эмиттера. Одинаковые области эмиттера и коллектора обуславливают симметрию латерального транзистора, а это значит, что прямой и инверсный коэффициенты усиления по току почти одинаковы. Пробивные напряжения обоих переходов также практически одинаковы и составляют 30…50 В.
Важным параметром, характеризующим быстродействие транзистора, является время рассасывания избыточных зарядов. Для уменьшения его, интегральный транзистор легируется золотом, которое имеет большой коэффициент диффузии и проникает во все области транзистора (базу, эмиттер, коллектор). Это приводит к созданию дополнительных центров рекомбинации. В результате уменьшается время жизни неосновных носителей в базе и снижаются коэффициенты передачи h21э, h21б. Чтобы сохранить высокие значения h21э, h21б, уменьшив время рассасывания, переход база-коллектор шунтируют диодом Шотки. Такие транзисторы называют транзисторами с барьером Шотки. В отличие от планарного транзистора у транзисторов с барьером Шотки базовое контактное отверстие расширено в сторону коллекторной области n–типа (рис. 7.10, а). Диод Шотки образуется в месте контакта металла с высокоомной коллекторной областью n–типа. Диод Шотки оказывается включенным параллельно коллекторному переходу (рис. 6.10, б).

Рис.7.10 Структурная схема(а) и условное обозначение(б) транзистора с барьером Шоттки.
В режиме отсечки и в активном режиме потенциал коллектора выше потенциала базы, диод Шотки закрыт, и транзистор работает как обычный биполярный транзистор. При переходе из активного в режим насыщения потенциал коллектора становится меньше потенциала базы. Диод Шотки открывается, и основная часть тока базы поступает в коллектор через диод Шотки, минуя область базы транзистора. При этом не происходит накопления избыточного заряда в области базы, и при переключении транзистора из режима насыщения в активный или режим отсечки почти отсутствует процесс рассасывания избыточного заряда. Время рассасывания избыточного заряда определяется временем пролета электронов через базу и для транзисторов с достаточно тонкой базой менее 1 мкм составляет не более 1 нс.
Основная область применения транзисторов с диодом Шотки – это цифровые микросхемы с повышенным быстродействием, где транзисторы работают в режиме насыщения. На быстродействие работы транзистора в импульсном режиме, кроме времени рассасывания, сильно влияют время задержки, нарастания и спада, которые определяются барьерными емкостями переходов и емкостью нагрузки. Применение транзисторов с диодом Шотки позволяет повысить быстродействие цифровых микросхем в 2…5 раз.
В цифровых интегральных микросхемах широко используются особые транзисторные структуры – многоэмиттерные транзисторы, неимеющие дискретного аналога. Многоэмиттерные n–p–n транзисторы (МЭТ) отличаются от одноэмиттерных тем, что в их базовой области р–типа создается несколько эмиттерных областей (обычно 4…8). Структуры МЭТ получаются в едином технологическом процессе изготовления ИС вместе с одноэмиттерными интегральными транзисторами. Многоэмиттерный транзистор можно представить в виде совокупности отдельных n–p–n транзисторов, число которых равно числу эмиттеров (рис. 6.11, а), и имеющих общие коллектор и базу.
Под каждым эмиттером расположена активная область базы, а между соседними эмиттерами – пассивная область. Соседние эмиттеры вместе с разделяющей их пассивной областью базы образуют латеральный паразитный транзистор n–p–n типа. Роль коллектора в паразитном транзисторе выполняет эмиттер, на который подано отрицательное напряжение. Для устранения паразитного явления расстояние между соседними эмиттерами МЭТ делают больше диффузионной длины неосновных носителей заряда в базе.
Включение МЭТ осуществляется по схеме, представленной на рис. 7.11, б. МЭТ используется для создания микросхем транзисторно-транзисторной логики. В интегральных микросхемах часто используется инверсное включение МЭТ, при этом транзистор называют многоколлекторным транзистором (МКТ). Многоколлекторный транзистор находит применение в интегральных схемах с инжекционным питанием.

Рис 7.11 Многоэмиттерный транзистор (а) и его схема велючения(б).
Диоды в полупроводниковых ИМС можно получить на основе одинаковых транзисторных структур, выбирая соответствующую схему коммутации выводов транзистора.
Существует пять вариантов коммутации выводов транзистора для создания диода (табл. 6.1):
1. Переход база–эмиттер с разомкнутой цепью коллектора.
2. Переход база–эмиттер с коллектором, закороченным на базу.
3. Переход база–коллектор с разомкнутым эмиттером.
4. Переход база–коллектор с эмиттером, закороченным на базу.
5. Включены в параллель переходы база–эмиттер и база–коллектор.
В табл. 6.1 приведены также некоторые параметры интегральных диодов.
Таблица 7.1
| № | Тип диодного включения | Последовательное сопротивление | Напряжение пробоя, В | Обратный ток, нА |

| 
| » 7 | 0, 5…1, 0 | |

| 
| » 7 | 0, 5…1, 0 | |

| 
| > 40 | 0, 5…2, 0 | |

| 
| > 40 | 15…30 | |

| 
| » 7 | 15…40 |
Анализ параметров интегральных диодов показывает, что оптимальными вариантами включения являются схемы 1 и 2, имеющие малый обратный ток и малое прямое сопротивление. Малые пробивные напряжения таких диодов несущественны для низковольтных интегральных микросхем.
Некоторые схемы диодного включения используются в качестве стабилитронов. Конкретная схема включения диода выбирается в зависимости от необходимого напряжения стабилизации и ТКН. Для стабилизации напряжения до 7 В используется эмиттерный переход (табл. 6.1 схема 1), работающий в режиме электрического пробоя. ТКН у такого стабилитрона не превышает 0, 2 %/°C. Низковольтные стабилитроны получаются при прямом смещении p–n перехода, и напряжение стабилизации приблизительно равно высоте потенциального барьера и составляет порядка 0, 7 В. Для повышения напряжения стабилизации используется последовательное включение диодов, у которых используется переход база–эмиттер с коллектором, закороченным на базу.
Биполярные транзисторы с инжекционным питанием были предложены в 1971 году, в результате развития интегральной технологии и не имеют аналогов дискретных транзисторов. Отличительной особенностью биполярных транзисторов с инжекционным питанием является наличие дополнительной области с электропроводностью того же типа, что и у базы транзистора. Эту область называют инжектором, а p1–n1 переход инжекторным.
В связи с этим, транзистор с инжекционным питанием представляет собой четырехслойную структуру (рис. 7.12, а), в которой соединены p1–n1–p2 и n2–p2–n1 транзисторы между собой (рис.7.12, б).
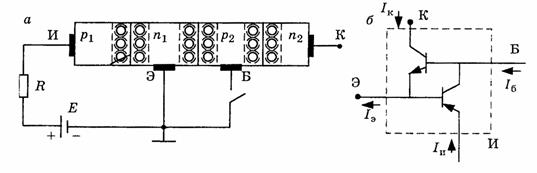

Рис.7.12. Схема включения(а) и модель планарного транзистора с инжекционным питанием (б)
Принцип действия транзистора с инжекционным питанием рассмотрим по схеме на рис. 7.12, а. Пусть на инжекторный переход подано прямое напряжение от источника питания Е. Последовательно включенный резистор R ограничивает напряжение и ток в инжекторном переходе. Тогда из области инжектора в область эмиттера инжектируются дырки, а из эмиттера в инжектор – электроны.
Для простоты понимания физических процессов, протекающих в транзисторе, принимаем одностороннюю инжекцию носителей. Учитываются только дырки, инжектированные в эмиттер. Рассмотрим работу транзистора, когда цепь база–эмиттер разомкнута.
В процессе инжекции дырок из инжектора в область эмиттера, в эмиттерной области у инжекторного p–n перехода создается избыточная концентрация дырок. А для сохранения электронейтральности области эмиттера, в эмиттер от внешнего источника поступают электроны. Избыточные электроны и дырки диффундируют вглубь эмиттера к эмиттерному переходу. Подойдя к эмиттерному n1–p2 переходу, дырки подхватываются полем перехода и перебрасываются в область базы, компенсируя частично заряд ионов акцепторной примеси. А электроны, подошедшие вместе с дырками к n1–p2 эмиттерному переходу компенсируют заряды положительно заряженных ионов донорной примеси. В результате этого снижается потенциальный барьер эмиттерного перехода, уменьшается сопротивление перехода, и переход смещается в прямом направлении. Это способствует перемещению дырок и электронов в область базы, что адекватно их инжекции из области эмиттера, а подойдя к p2–n2 коллекторному переходу смещают его в прямом направлении (таким же образом, как и эмиттерный переход).
В результате этого эмиттерный и коллекторный переходы транзистора n1–p2–n2 смещены в прямом направлении, сопротивление транзистора и падение напряжения на нем малы. Транзистор работает в режиме, близком к режиму насыщения, и его можно рассматривать как замкнутый электронный ключ.
Если цепь базы соединить с помощью выключателя с цепью эмиттера, то напряжение на эмиттерном переходе станет равным нулю. Дырки, достигшие эмиттерного перехода, перебрасываются в базу и компенсируются электронами, поступающими из внешней среды. В результате этого к коллекторному переходу p2–n2 перестают поступать носители, и сопротивление этого перехода резко возрастает, коллекторный переход смещается в обратном направлении. Транзистор n1–p2–n2 переходит в состояние, близкое к режиму отсечки, что соответствует разомкнутому электронному ключу. Роль выключателя может выполнять другой транзистор с инжекционным питанием, находящийся в режиме насыщения. Для осуществления режима переключения требуется ничтожно малая энергия 10-12 Дж. Это позволяет представить транзистор на эквивалентной схеме обычным биполярным транзистором, между эмиттером и базой которого включен источник тока Iг, функцию которого выполняет инжектор. Величина тока генератора Iг определяется количеством дырок, инжектируемых через инжекторный переход и поступающих в базу p2.
Выходные характеристики транзистора с инжекционным питанием представлены на рис. 7.14. Если цепь базы разомкнута (Iб=0), то максимальный ток внешнего источника напряжения меньше или равен Iк нас. При замкнутой цепи база–эмиттер транзистор работает в режиме, близком к отсечке, и через транзистор протекает обратный ток, мало зависящий от приложенного напряжения.


Рис.7.14 Статические выходные характеристики транзистора с инжекционным питанием
Данные транзисторы являются основой для создания логических микросхем с инжекционным питанием (И2Л), могут нормально работать при значительных изменениях напряжения и тока питания. А также в широком диапазоне температур: от –60° до +125°C. Логические микросхемы с инжекционным питанием широко применяются при создании больших интегральных схем (БИС) и сверхбольших интегральных схем (СБИС).
Полупроводниковые приборы c зарядовой связью - это полупроводниковый прибор, в котором происходит накопление неосновных носителей под электродами МОП-структур и перемещение этих носителей от одного электрода к другому.
Электрический сигнал в приборах с зарядовой связью (ПЗС) представлен не напряжением или током, как в обычных аналоговых или цифровых схемах, а зарядом неосновных носителей – зарядовым пакетом.
Идею создания запоминающих устройств высказал в 1934 году В.К. Зворыкин, а американские ученые Н. Бойл и Г. Смит изготовили ПЗС в 1969 году.
Приборы с зарядовой связью (ПЗС) – представляет собой полупроводниковый прибор, имеющий большое число затворов изолированных от подложки и расположенных очень близко друг к другу. От истока происходит перенос пакета неосновных носителей заряда под затворами к стоку.
Таким образом ПЗС представляет собой семейство полевых транзисторов. Однако принцип работы основан на движении неосновных носителей заряда как у биполярного транзистора.
В отличии от полевого транзистора у ПЗС отсутствует проводящий канал между истоком и стоком. Перенос носителей от истока к стоку, т.е. движение заряда, происходит от затвора к затвору за счёт подачи на затворы управляющих напряжений.
В связи с этим ПЗС является динамическим полупроводниковым прибором работа которого возможна только при подаче постоянно изменяющегося по величине управляющего напряжения.
Принцип действия ПЗС основан на накоплении и хранении заряда неосновных носителей в потенциальных ямах, образующихся у поверхности полупроводника под действием внешнего электрического поля, прикладываемого к затвору, и перемещении этого заряда вдоль поверхности при изменении соответствующим образом управляющих напряжений на соседних элементах. Основными элементами ПЗС являются однотипные МОП-конденсаторы, близко расположенные на одном кристалле и взаимодействующие между собой. На входе и выходе цепочки МОП- конденсаторов используются или диоды, или полевые транзисторы (рис. 7.15).

рис. 7.15. Структура МОП- полевого транзистора в ПЗС
Для того, чтобы между соседними затворами обеспечивалось взаимодействие с помощью переноса зарядовых пакетов, расстояние между затворами должно быть малым по сравнению с толщиной обедненных слоев под затворами. Размер каждого электрода вдоль цепочки составляет 10…15 мкм, а промежутки между электродами 2…4 мкм. Благодаря непосредственной зарядовой связи между соседними элементами в ПЗС не нужны сигнальные проводники, как в интегральных схемах на транзисторах. Слой диэлектрика имеет толщину порядка 0, 1 мкм.
Для ПЗС характерны два режима работы: хранения и передачи информационного заряда. Информационный заряд может храниться в одном или нескольких конденсаторах не очень длительное время. При длительном времени хранения информационного заряда вследствие процессов термогенерации происходит накопление паразитного заряда дырок в инверсном слое и к заполнению потенциальных ям.
При работе ПЗС в аналоговых устройствах паразитный заряд изменяет величину полезного информационного сигнала, что вызывает искажение хранимой аналоговой информации. Для современных ПЗС максимальное время хранения заряда лежит в пределах от сотен миллисекунд до десятков секунд.
На рис. 7.16, а изображен так называемый трехтактный симметричный ПЗС, имеющий входную цепь, цепь переноса и выходную цепь. Входная цепь состоит из истока с p+–областью под ним и входного затвора, который управляет движением дырок из p+–области истока в первую потенциальную яму. Таким образом ввод зарядового пакета осуществляется инжекцией дырок через входной p+–n переход, когда напряжение, подаваемое на затвор, больше Uпор и достаточное для образования проводящего канала под входным затвором.

Рис.7.16. Схема и рабочие диаграммы ПЗС на основе трехтактного регистра сдвига.
Цепь переноса состоит из ряда затворов, управляющих потенциалом на границе полупроводника и окисла. Перенос зарядового пакета от первого МОП-конденсатора к другому и далее происходит при условии, что напряжения на электродах отрицательны и напряжение последующего электрода по абсолютной величине больше напряжения предыдущего. Импульс напряжения (тактовые напряжения), подаваемые на электроды 1, 2, 3 для переноса заряда, имеют амплитуду 10…20 В.
Если к электроду 1 при наличии проводящего канала под входным затвором приложить отрицательное напряжение, превышающее по абсолютному значению пороговое, то у поверхности полупроводника образуется обедненная область. Образовавшаяся область является потенциальной ямой для неосновных носителей заряда, и под действием напряжения, приложенного к электроду 1, осуществляется инжекция дырок в потенциальную яму, где они и хранятся (рис. 7.16, б). Для передачи зарядового пакета к соседнему электроду прикладывается более отрицательное напряжение (по сравнению с напряжением хранения) – напряжение записи, при этом напряжение на входном затворе снимается (проводящий канал исчезает). Напряжение записи создает более глубокую потенциальную яму под этим электродом и образует продольное электрическое поле в области разделяющей электроды. После переноса зарядового пакета в потенциальную яму потенциал электрода снизится (по абсолютному значению) до напряжения хранения. При следующих тактах изменения напряжения на электродах в цепи переноса будет происходить дальнейшее продвижение зарядового пакета к выходной цепи (рис. 7.16, г, д). Если в потенциальной яме, подходящей к p–n переходу стока, отсутствует информационный зарядовый пакет, то и не будет изменения тока в цепи стока. Использование во выходной цепи МОП-транзистора позволяет осуществить неразрушающее считывание зарядового пакета.
Когда информационный зарядовый пакет переместится в потенциальную яму на границе к p–n переходу стока, дырки втягиваются в область стока. Это вызывает появление импульса тока или изменение напряжения на стоке (рис.7.16, г).
ПЗС способен передавать фиксированные порции электрического заряда от истока к стоку. Величина передаваемого заряда однозначно определяется величиной управляющего напряжения Uупр, а время задержки передачи
заряда зависит от частоты изменения напряжения на затворах. С уменьшением частоты изменения напряжения переноса величины заряда, которая достигает стока уменьшается. Однако для увеличения коэффициента передачи частота изменения напряжения должно увеличиваться. Но увеличение частоты
ограничивается конечным временем перетекания объёмного заряда из одной
потенциальной ямы в другую.
В связи с этим частота изменения управляющего напряжения ограничена
Как снизу так и сверху и находится в диапазоне от десятков кГц до десятковМГц. Быстродействие ПЗС определяется режимом передачи зарядового информационного пакета от одного электрода к другому, осуществляемой в основном за счет дрейфа и диффузии в конце переноса неосновных
носителей, которая совершается значительно медленнее. Практически
быстродействие ПЗС характеризуется предельной частотой 1 ГГц.
Приборы с зарядовой связью в настоящее время выпускаются в виде БИС и СБИС. По выполняемым функциям устройства на ПЗС можно разделить на три группы: цифровые, аналого-цифровые и оптоэлектронные.
В цифровых устройствах ПЗС используются как регистры сдвига, постоянные запоминающие устройства (ПЗУ), обеспечивающие емкость хранения 106…107 бит на кристалле с частотой выдачи информации 1…10 МГц. Запоминающие устройства на ПЗС с произвольной выборкой по считыванию позволяют считывать информацию из произвольной ячейки матрицы на ПЗС.
Аналого-цифровые устройства ПЗС используются для обработки сигналов в технике связи и радиотехнических устройствах (линии задержки, полосовые фильтры, мультиплексоры). В линиях задержки входной аналоговый сигнал преобразуется в дискретные зарядовые пакеты и через время задержки поступает на выход ПЗС. В мультиплексорах несколько входных сигналов параллельно вводятся в ПЗС, а затем последовательно выводятся на выход ПЗС.
ПЗС также используются в качестве компенсирующих устройств при магнитной записи звуковых колебаний и видеосигналов, для коррекции звука и изображения в цветном телевидении.
В оптоэлектронных ПЗС используется эффект фоточувствительности для создания одномерных и плоскостных приборов, таких как усилители с плавающим затвором, фотоячейки, приемники изображения для портативных телевизионных камер.
Работа ФОТО-ПЗС основана на генерации электронно-дырочных пар, число которых пропорционально освещенности, каждый затвор получает заряд, зависящий от освещенности падающего света.
Основными параметрами элементов ПЗС являются: рабочая амплитуда управляющих напряжений, предельные тактовые частоты (минимальная и максимальная), максимальная величина зарядового пакета, эффективность передачи заряда, рассеиваемая мощность.
Рабочая амплитуда управляющих напряжений должна обеспечивать требуемую величину зарядового пакета и полного смыкания обедненных слоев соседних элементов при уменьшении расстояния между затворами и увеличении емкости диэлектрика. При этом управляющее напряжение уменьшается и лежит в пределах 10…20 В.
Максимальная величина зарядового пакета характеризует управляющую способность ПЗС и пропорциональна амплитуде управляющего напряжения и площади затвора.
Минимальная тактовая частота fт мин обратно пропорциональна максимально допустимому времени хранения зарядового элемента в одном пакете. За счет тепловой генерации и свойств материала накопление заряда в пустых потенциальных ямах может произойти за время от сотых долей до единиц секунд, что соответствует fт мин = 30…300 Гц.
Максимальная тактовая частота fт макс определяется временем переноса заряда из одной потенциальной ямы в другую, и она составляет десятки МГц.
Время переноса зарядового пакета связано с эффективностью переноса.
Эффективность переноса (передачи) заряда h – показывает какая доля заряда переносится из одной потенциальной ямы в другую. Эффективность переноса определяет максимальное число элементов, через которые может передаваться зарядовый пакет и составляет величину порядка 0, 999…0, 99999. Эффективность передачи очень близка к 1, поэтому часто пользуются коэффициентом потерь (неэффективностью передачи) n=1–h, который составляет 10-3…10-5.
Рассеиваемая мощность элементов ПЗС определяется только в режиме переноса зарядов и увеличивается с ростом тактовой частоты, амплитуды управляющего напряжения и величины зарядового пакета, и составляет менее 1 мкВт.
|
|