
Главная страница Случайная страница
Разделы сайта
АвтомобилиАстрономияБиологияГеографияДом и садДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеталлургияМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРелигияРиторикаСоциологияСпортСтроительствоТехнологияТуризмФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Вольтамперная характеристика p-n-перехода
|
|
Рассмотрим теперь pn -переход, к которому приложено прямое смещение Vсм (минус батареи к n -типу, плюс – к p -типу). Для того чтобы описать вольт-амперные характеристики (ВАХ) pn -перехода допустим, что все приложенное внешнее напряжение падает на pn- переходе.
При прямом смещении высота потенциального барьера понижается на qVсм по сравнению с равновесным состоянием, соответственно изменяется и толщина ОПЗ:
 . .
| (5.17) |
Понижение потенциального барьера приводит к увеличению потока основных носителей заряда по сравнению с равновесным состоянием. Под действием диффузионных процессов основные носители (nn и pp) перемещаются в соседнюю область, становясь неосновными носителями (pn и np). Образовавшийся градиент концентрации неосновных носителей приводит к появлению диффузионных токов неосновных носителей заряда, он направлен от ОПЗ вглубь полупроводника (рис. 5.4). При этом направления диффузионных токов, создаваемых pn и np совпадают, в то время как их потоки направлены в разные стороны.
Ограничимся пока рассмотрением n -области pn -перехода. В n -области появившиеся неосновные носители (дырки) с концентрацией  (рис. 5.4, а) создают в первый момент вблизи контакта положительный объемный заряд, однако через максвелловское время релаксации будет скомпенсирован объемным зарядом основные носителей заряда – электронов, которые под действием электрического поля, созданного избыточными дырками, будут подтянуты в количестве
(рис. 5.4, а) создают в первый момент вблизи контакта положительный объемный заряд, однако через максвелловское время релаксации будет скомпенсирован объемным зарядом основные носителей заряда – электронов, которые под действием электрического поля, созданного избыточными дырками, будут подтянуты в количестве  из глубины n -области, а в n -область электроны поступит из внешней цепи. Электроны будут двигаться за счет поля, создаваемого избыточными дырками и по свой природе является дрейфовым.
из глубины n -области, а в n -область электроны поступит из внешней цепи. Электроны будут двигаться за счет поля, создаваемого избыточными дырками и по свой природе является дрейфовым.
В состоянии термодинамического равновесия дрейфовый ток основных носителей должен компенсировать диффузионный ток неосновных носителей и суммарный ток через pn -переход равен нулю.

|
| Рис. 5.4 |
Во всех частях электронного полупроводника будет соблюдаться электронейтральность, но в приконтактной области pn -перехода концентрация электронов и дырок будет повышена на  =
=  по сравнению с равновесным состоянием. Введение в полупроводник носителей заряда с помощью pn -перехода при подаче на него прямого смещения в область, где это носители заряда являются неосновными, называют инжекцией. Теперь концентрация дырок в n -области вблизи контакта будет равна:
по сравнению с равновесным состоянием. Введение в полупроводник носителей заряда с помощью pn -перехода при подаче на него прямого смещения в область, где это носители заряда являются неосновными, называют инжекцией. Теперь концентрация дырок в n -области вблизи контакта будет равна:
 . .
| (5.18) |
Для ее нахождения в стационарном случае на границе с ОПЗ (при x=Wn) нужно в (5.5) место qφ к использовать значение q(φ к-Vсм).
 , ,
| (5.19) |
Таким образом, концентрация неосновных носителей в низколегированной области (базе) зависит от концентрации носителей в высоколегированной области (эмиттере) и от напряжения смещения, приложенного к pn-переходу (рис.5.5).

|
| Рис. 5.5 |
Из (5.19) следует, что концентрация избыточных носителей в n -области при x=Wn равна:
 . .
| (5.20) |
Аналогичные явления происходят в p -области: сюда из n - области инжектируются электроны и концентрация избыточных электронов при x=-Wp составит:
 . .
| (5.21) |
Если к pn -переходу приложено обратное смещение (минус батареи к p -типу, плюс – к n -типу) (рис. 5.5, б), потенциальный барьер повышается на qVсм. Толщина слоя ОПЗ увеличивается:
 . .
| (5.22) |
Чем сильнее переход смещен в обратном направлении, тем выше потенциальный барьер, и тем меньшее количество основных носителей заряда способно преодолеть возросший потенциальный барьер. В соответствии с этим количество неосновных носителей заряда в приконтактной области уменьшается по сравнению с равновесным состоянием, следовательно, уменьшается и количество основных носителей заряда вследствие соблюдения электронейтральности. Это явление носит название экстракции носителей заряда.
Таким образом, при обратном смещении pn -перехода ток основных носителей заряда будет меньше, чем при равновесном состоянии, а ток неосновных носителей заряда практически не изменится. Поэтому суммарный ток через pn -переход будет направлен от n -области к p -области и с увеличением обратного напряжения вначале будет незначительно расти, а затем стремиться к некоторой величине, называемой током насыщения Js.
Для аналитического расчета ВАХ pn -перехода примем следующие допущения:
1. Модель электронно-дырочного перехода одномерная; p - и n -области имеют бесконечную протяженность.
2. Переход тонкий, носители заряда пролетают через ОПЗ без рекомбинации (ОПЗ стянут в линию).
3. Обе квазинейтральные области сильно легированы, падением напряжения на них можно пренебречь. Вся внешняя разность потенциалов приложена к pn -переходу.
4. Рекомбинацию считаем линейной.
5. Уровень инжекции мал (Δ np< < pp 0, Δ p< < nn 0).
Чтобы рассчитать ВАХ pn -перехода, нужно найти закон изменения концентрации свободных носителей заряда в p - и n - областях. Для этого необходимо решить уравнения непрерывности:

| (5.23) |

| (5.24) |
Для любых полей плотность полного тока дырок и электронов, определяющаяся дрейфовыми и диффузионными составляющими, будет равна:

| (5.25) |
где  - напряженность внешнего электрического поля.
- напряженность внешнего электрического поля.
Общий ток через образец должен оставаться постоянным:  .
.
Рассмотрим n -область. При нахождении статической ВАХ концентрация носителей не меняется во времени. В стационарном состоянии

| (5.26) |

| (5.27) |
Эти уравнения справедливы без учета встречных потоков электронов и дырок, но возрастание концентрации носителей увеличивает вероятность их рассеяния! Для учета этих процессов, проведем следующие операции: учитывая квазинейтральность области Δ nn= Δ pn, и соотношение Эйнштейна (3.24), умножая уравнение (5.26) на  и уравнение (5.27) на
и уравнение (5.27) на  , для стационарного случая получим:
, для стационарного случая получим:

| (5.28) |
где  - коэффициент амбиполярной диффузии,
- коэффициент амбиполярной диффузии,  - амбиполярное время жизни.
- амбиполярное время жизни.
В случае малого уровня инжекции (т.е. при  в полупроводнике n -типа) уравнение (5.25) упрощается:
в полупроводнике n -типа) уравнение (5.25) упрощается:

| (5.29) |
Но в квазинейтральной области напряженность внешнего электрического поля равна нулю! Таким образом, плотность тока в n -области определяется диффузионным током дырок, зависящим от их градиента концентрации.

| (5.30) |
Используя соотношение  , получим:
, получим:

| (5.31) |
Общее решение такого уравнения имеет вид:

| (5.32) |
Так как при движении избыточных носителей в объем полупроводника ( ) их концентрация спадает до нуля, постоянная B должна быть принятой равной нулю. Тогда из (5.16) получим:
) их концентрация спадает до нуля, постоянная B должна быть принятой равной нулю. Тогда из (5.16) получим:
 . .
| (5.33) |
Концентрация неравновесных дырок на границе ОПЗ при x=Wn, согласно (5.19) равна:
 , ,
| (5.34) |
учитывая это, находим при x=Wn:

| (5.35) |
Окончательно закон изменения концентрации неравновесных дырок в n -области при x> Wn принимает вид:
 . .

| (5.36) |
На основании (5.25) при  =0 получаем:
=0 получаем:

| (5.37) |
На границе ОПЗ при x=Wn, получим:

| (5.38) |
Проведем аналогичные рассуждения для p -области при x< -Wp и получим:
 . .
| (5.39) |

| (5.40) |
На границе ОПЗ при x=-Wp, получим:

| (5.41) |
Следовательно, ВАХ тонкого pn -перехода описывается уравнением:

| (5.42) |
где плотность тока насыщения

| (5.43) |
Формулу (5.42) часто называют формулой Шокли.
Таким образом, при прямом смещении ток, текущий через pn -переход, экспоненциально возрастает, а обратный ток растет медленно и достигает тока насыщения. Выпрямляющие свойства pn -перехода тем лучше, чем меньше ток насыщения. Плотность тока насыщения уменьшается с ростом концентрации основных носителей заряда (т.е. с увеличением степени легирования областей). Причем, изменяя степень легирования областей, мы можем задавать условия для преимущественного протекания через барьер электронных или дырочных потоков. Именно эти свойства избирательного управления потоками носителей заряда легли в основу большей части биполярных приборов.
Кривые распределения концентрации равновесных и избыточных носителей заряда и токов через pn -переход для прямого и обратного смещений изображены на рис. 5.6.

|
| Рис. 5.6. Концентрации носителей заряда и токи в p-n-переходе при прямом (а) и обратном (б) смещении |
Токи неосновных носителей спадают до нуля от границы ОПЗ в глубь полупроводника, поскольку спадают градиенты концентраций носителей.
На границе ОПЗ (х=0) инжекционный ток дырок  и инжекционный ток электронов
и инжекционный ток электронов  составляют полный ток через переход
составляют полный ток через переход 
 +
+  . Полный ток постоянен во всей структуре диода. Тогда рекомбинационные токи основных носителей получим вычитанием в каждом сечении структуры из полного тока ток неосновных носителей. Уменьшение тока основных носителей, полученное нами формально, имеет физическое обоснование. В силу электронейтральности распределение приращений концентрации основных носителей повторяет распределение приращения неосновных носителей. Диффузионные составляющие токов основных носителей в каждой области вычитаются из дрейфовых токов в этих областях, поскольку направления дрейфового и диффузионного тока противоположны. При обратных смещениях (
. Полный ток постоянен во всей структуре диода. Тогда рекомбинационные токи основных носителей получим вычитанием в каждом сечении структуры из полного тока ток неосновных носителей. Уменьшение тока основных носителей, полученное нами формально, имеет физическое обоснование. В силу электронейтральности распределение приращений концентрации основных носителей повторяет распределение приращения неосновных носителей. Диффузионные составляющие токов основных носителей в каждой области вычитаются из дрейфовых токов в этих областях, поскольку направления дрейфового и диффузионного тока противоположны. При обратных смещениях ( < 0) токи выражаются в соответствии с (5.37) и (5.40) формулами:
< 0) токи выражаются в соответствии с (5.37) и (5.40) формулами:

| (5.44) |

| (5.45) |
Абсолютное значение полного обратного тока

| (5.46) |
Рассмотрим Si pn -переход.  = Na =1018 cм-3,
= Na =1018 cм-3,
 = Nd =1015 cм-3, в этом случае
= Nd =1015 cм-3, в этом случае
 = 105 cм-3,
= 105 cм-3,  =102 cм-3
=102 cм-3
При прямом смещении:
Пусть  =0, 6 В,
=0, 6 В,  =
= 
 =1015 cм-3 равна
=1015 cм-3 равна 
 =1012 cм-3
=1012 cм-3
При обратном смещении:
Уже при  =-3
=-3  =-78 мВ,
=-78 мВ,  , т.е. граничные концентрации составляют 5% от исходных
, т.е. граничные концентрации составляют 5% от исходных  и
и  .
.
Распределение концентраций неосновных носителей описываются соотношениями:

Толщиной ОПЗ пренебрегли, исходя из  .
.

Аналогично для электронов в p-области:

Знак показателя экспоненты для  определяется выбором «0» на оси х.
определяется выбором «0» на оси х.
 ,
, 
Параметры D и L зависят от концентраций примеси в областях. Для наших прикидок реальными будут:  =2, 5 см2/с,
=2, 5 см2/с,  =25 см2/с,
=25 см2/с,  =14∙ 10-4 см,
=14∙ 10-4 см,  =20∙ 10-4 см. Тогда
=20∙ 10-4 см. Тогда  =0, 3∙ 10-10 А/см2,
=0, 3∙ 10-10 А/см2,  =2∙ 10-13 А/см2. Разница определяется главным образом отличием исходных значений
=2∙ 10-13 А/см2. Разница определяется главным образом отличием исходных значений  = 105 cм-3,
= 105 cм-3,  =102 cм-3.
=102 cм-3.
Оценим состав токов через pn -переход. Для прямого смещения, учитывая значения экспоненциального сомножителя  , получим:
, получим:
 А/см2,
А/см2,
 А/см2.
А/см2.
Ток через pn -переход является практически дырочным в следствие сильного легирования p- области и слабого легирования n- области.
Оценим, насколько справедливо в нашем примере предположение, что напряжение смещения приложено только к pn -переходу. Для полученного полного тока определим падение напряжения на толще n - и p -областей, приняв длину n -области  =0, 01 см, длину p -области 1 мкм=10-4 см. Проводимости σ n = qμ nn, σ p = qμ pp. Подвижности μ n и μ p зависят от концентраций примеси в полупроводниках, исходя из данных, приведенных в литературе (Зи, Т.1, с. 34). μ n = 300 см2/В∙ с, μ p = 100 см2/В∙ с.
=0, 01 см, длину p -области 1 мкм=10-4 см. Проводимости σ n = qμ nn, σ p = qμ pp. Подвижности μ n и μ p зависят от концентраций примеси в полупроводниках, исходя из данных, приведенных в литературе (Зи, Т.1, с. 34). μ n = 300 см2/В∙ с, μ p = 100 см2/В∙ с.
σ n = qμ nn= 
σ p = qμ pp= 
Падение напряжения на n - и p -слоях


Таким образом, 10% от напряжения падает на слаболегированной области.
Изменение концентрации носителей в приконтактной области должно повлечь за собой изменение положения уровня Ферми. При приложении к pn -переходу внешнего напряжения состояние полупроводника становится неравновесным и характеризуется квазиуровнями Ферми Fn и Fp. Избыточные носители существуют в приконтактной области справа и слева от pn -перехода на расстоянии нескольких диффузионных длин и в этих областях квазиуровнями Ферми будут зависеть от координаты x (рис. 5.7).

|
| Рис. 5.7. Энергетические диаграммы при прямом и обратном смещении |
Повышение температуры приводит к росту собственной концентрации, а следовательно, и к росту тока насыщения (рис. 5.8), поэтому стремятся использовать полупроводниковые материалы с большей запрещенной зоной (Si, GaAs, SiC).

|
| Рис. 5.8. Изменение ВАХ при повышении температуры |
5.3 Температурные зависимости ВАХ pn -перехода
Повышение температуры приводит к росту собственной концентрации,

| (2.16) |
а следовательно, и к росту тока насыщения (рис. 5.8),

| (5.43) |
Контактная разность потенциалов с ростом температуры уменьшается, т.к. при высоких температурах уровень Ферми стремится к середине запрещенной зоны и qφ к стремится к нулю.
Поэтому стремятся использовать полупроводниковые материалы с большей запрещенной зоной (Si, GaAs, SiC).
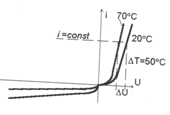
|
| Рис. 5.8. Изменение ВАХ при повышении температуры |
5.3 Влияние генерационно-рекомбинационных процессов на ВАХ pn- перехода.
При вводе ВАХ pn -перехода предполагалось, что генерацией носителей заряда в обедненной области шириной W можно пренебречь. Это условие действительно справедливо для полупроводников, ширина запрещенной зоны которых невелика (например, в Ge). Однако для таких материалов как Si и GaAs генерационно-рекомбинационный ток в ОПЗ может быть сравним с током насыщения диода, создаваемым неосновными носителями, и даже превосходить его.
Наибольшую роль в генерационно-рекомбинационных процессах играют центры захвата (ловушки), энергетические уровни которых расположены вблизи середины запрещенной зоны полупроводника.
При прямом смещении pn -перехода высота потенциального барьера снижается, поток основных носителей из квазинейтральных областей возрастают и внутри ОПЗ процессы рекомбинации преобладают над процессами генерации носителей.
При обратном смещении pn -перехода высота потенциального барьера увеличивается, ОПЗ обеднен основными носителями, процессы генерации преобладают над процессами рекомбинации. В результате тепловой генерации электронно-дырочных пар в ОПЗ образуется ток генерации, который складывается с током насыщения.
Ширина ОПЗ зависит от смещения:
 . .
| (5.17) |
Следовательно, весь объем ОПЗ при прямом смещении уменьшается, а при обратном смещении увеличивается. В соответствии с этими изменениями объема изменяется вклад генерационно-рекомбинационных процессов.
Согласно теории генерационно-рекомбинационного тока ВАХ описывают соотношением:

| (5.39) |
где m  2 – параметр, зависящий, от характера распределения примесей в pn -переходе.
2 – параметр, зависящий, от характера распределения примесей в pn -переходе.

| (5.40) |
где ni – концентрация носителей заряда в ОПЗ (допускается, что его проводимость близка к собственной), τ eff – эффективное время жизни электронно-дырочных пар в ОПЗ, W (Vсм) – ширина ОПЗ.
Для оценки эффективного времени жизни носителей в ОПЗ можно воспользоваться следующей формулой:

| (5.41) |
Для многих практических случает можно использовать следующие формулы:
- прямое смещение pn -перехода:
 , ,
| (5.42) |
- обратное смещение pn -перехода:
 . .
| (5.43) |
Таким образом, общий ток идеального pn-перехода равен сумме диффузионной (5.37) и генерационно-рекомбинационной компонент и (5.39) (рис. 5.9).

|
| Рис. 5.9 |
5.4 Барьерная емкость pn -перехода
Как следует из распределения концентрации свободных носителей, в ОПЗ резко падают, сопротивление ОПЗ велико по сравнению с квазинейтральными областями, то есть pn- переход обладает свойствами конденсатора. Барьерная емкость ступенчатого pn -перехода с площадью S может быть определена по формуле:
 . .
| (5.44) |
где ε 0 – диэлектрическая постоянная, ε s – диэлектрическая проницаемость полупроводника, W – ширина ОПЗ.
Соответствующая зависимость барьерной емкости от напряжения, показана на рис. 5.10.

|
| Рис. 5.10 |
Емкость pn -перехода может изменяться в значительных пределах, что позволило использовать это свойство в варикапах.
5.5 Диффузионная емкость pn -перехода
При прямом включении pn -перехода носители диффундируют через барьер и накапливаются в соседней области. Количество инжектированного в соседнюю область заряда зависит от величины приложенного к pn -переходу напряжения. Изменение инжектированного заряда при изменении приложенного напряжения может характеризоваться емкостью, которую принято называть диффузионной.
| C диф = dQ/dV. | (5.45) |
где Q – инжектированный заряд.
 , ,
| (5.50) |
Диффузионная емкость pn-перехода тем больше, чем больше прямой ток и время жизни неосновных носителей заряда, т.е. от глубины проникновения носителей заряда в соседнюю область.
Полная емкость pn-перехода равна сумме барьерной и диффузионной емкостей. При прямых напряжениях барьерная емкость много меньше диффузионной, а при обратных напряжениях она значительно превышает ее. Соотношения между барьерной и диффузионной емкостью определяют частотные зависимости pn -перехода.
5.6 Пробой pn- перехода
При увеличении напряжения на pn -переходе при достижении некоторого напряжения пробоя Vпроб начинается резкое возрастание тока, которое может привести к физическим изменениям структур и выходу pn -перехода из строя. Существует три основных механизма пробоя: лавинный, туннельный и тепловой (Рис. 5.11).

|
| Рис. 5.11. ВАХ обратной ветви pn -перехода в случае лавинного, туннельного и теплового пробоя |
5.6.1 Лавинный пробой pn- перехода
Рассмотрим случай однородного электрического поля в полупроводнике. Если двигаясь вдоль силовых линий электрического поля электрон на расстоянии, равном длине свободного пробега lсв, наберет энергию, равную либо большую, чем  , то этот электрон может вызвать генерацию еще одной электронно- дырочной пары. Вновь образованные носители, разгоняясь в электрическом поле, принимают участке в дальнейшем образовании электронно-дырочных пар. Процесс нарастания числа носителей со временем носит лавинный характер, поэтому этот тип пробоя и называют лавинным. На рис. 5.12 показана схема, иллюстрирующая лавинный пробой.
, то этот электрон может вызвать генерацию еще одной электронно- дырочной пары. Вновь образованные носители, разгоняясь в электрическом поле, принимают участке в дальнейшем образовании электронно-дырочных пар. Процесс нарастания числа носителей со временем носит лавинный характер, поэтому этот тип пробоя и называют лавинным. На рис. 5.12 показана схема, иллюстрирующая лавинный пробой.

|
| Рис. 5.12. Схема, иллюстрирующая лавинный пробой в однородном полупроводнике: а) распределение электрического поля, доноров и акцепторов и свободных носителей; б) распределение токов; в) зонная диаграмма, иллюстрирующая лавинное умножение в ОПЗ |
Размеры геометрической области полупроводника W, в которой происходит лавинное умножение, должны быть существенно больше длины свободного пробега электрона lсв. Соотношения, определяющие условие лавинного пробоя, будут следующие:
 , , 
| (5.51) |
Одним из параметров лавинного пробоя является коэффициент лавинного умножения M, определяемый как количество актов лавинного умножения в области сильного электрического поля, для которого справедливо следующее эмпирическое соотношение Миллера:

| (5.52) |
где J0 – ток до умножения (равный сумме тока насыщения и генерационного), n – коэффициент, который зависит от материала и профиля легирования pn -перехода, этот коэффициент может иметь значения от 1 до 6.
Напряжение лавинного пробоя зависит от степени легирования p - и n -областей. Так, например для резкого кремниевого p + n -перехода (p +- означает сильное легирование p -области) зависимость напряжения пробоя от степени легирования n -области имеет вид:

| (5.53) |
где Eg – ширина запрещенной зоны в эВ, N – концентрация примеси в слаболегированной области, см-3. Соответствующая зависимость напряжения пробоя от степени легирования для резкого несимметричного перехода для pn -переходов, изготовленных из разных материалов, показана на рис. 5.13.

|
| Рис. 5.13. Зависимость напряжения лавинного пробоя от концентрации примеси в низколегированной области для резкого pn -перехода |
Напряжение лавинного пробоя кремниевого pn -перехода с линейным распределением примеси (то есть при изменении примеси по линейному закону) определяется формулой:

| (5.54) |
где а – градиент концентрации примеси, см-4.
Температурная зависимость напряжения лавинного пробоя определяется уменьшением длины свободного пробега носителей заряда с увеличением температуры. При этом величина напряжения пробоя увеличивается, так как энергию, необходимую для разрыва ковалентных связей носители могут набрать при больших напряжениях.
5.6.2 Туннельный (полевой, зинеровский) пробой pn- перехода
Если p - и n -области сильно легированы, то ширина ОПЗ становится малой. Форма потенциального барьера обусловлена полем pn -перехода близка к треугольной (рис. 5.14), и появляется вероятность для электронов из валентной зоны проникнуть в зону проводимости, туннельным способом. Рассмотрим зонную диаграмму диода с pn -переходом при обратном смещении.
 б
б
|
| Рис. 5.14. Зонная диаграмма диода на базе сильнолегированного pn- перехода при обратном смещении |
Для туннельного эффекта характерно то, что электроны после преодоления барьера не изменяют энергии. Чтобы этот эффект имел место, электрическое поле должно быть настолько сильным, чтобы обеспечить такой наклон зон, при котором заполненные электронами уровни валентной зоны оказались напротив незаполненных энергетических уровней разрешенной зоны, а ширина потенциального барьера сравнима с дебройлевской длиной волны электрона.
Для барьера треугольной формы получено аналитическое выражение для зависимости туннельного тока Iтун от напряженности электрического поля Е следующего вида:

| (5.55) |
За напряженность электрического поля пробоя  пр условно принимают такое значение поля
пр условно принимают такое значение поля  , при котором происходит десятикратное возрастание обратного тока: Iтун = 10·I0. При этом для pn -переходов из различных полу-проводников величина электрического поля пробоя
, при котором происходит десятикратное возрастание обратного тока: Iтун = 10·I0. При этом для pn -переходов из различных полу-проводников величина электрического поля пробоя  пр составляет значения: кремний Si:
пр составляет значения: кремний Si:  пр = 4·105 В/см; германий Ge:
пр = 4·105 В/см; германий Ge:  пр = 2·105 В/см.
пр = 2·105 В/см.
Зависимость  для германиевых и кремниевых pn -переходов показана на рис. 5.12 штриховыми линиями.
для германиевых и кремниевых pn -переходов показана на рис. 5.12 штриховыми линиями.
Из рисунка видно, что туннельный пробой в германиевых pn -переходах имеет место при концентрациях примеси, превосходящей 1017 см-3, а в кремнии – соответственно 1018 см-3.
Напряжение туннельного пробоя сравнительно слабо зависит от температуры. Однако с ростом температуры ширина запрещенной зоны германия и кремния уменьшается, вероятность туннелирования возрастает, и величина критической напряженности поля уменьшается. Поэтому напряжение туннельного пробоя уменьшается.
Поскольку напряжение, при котором возникает лавинный и туннельный пробой достаточно стабильно, этот эффект используется для создания приборов, падение напряжения на которых остается стабильным при изменении тока – стабилитронов.
5.6.3 Тепловой пробой pn- перехода
При увеличении обратного напряжения увеличивается мощность, рассеиваемая в переходе в виде тепла, поэтому для pn -переходов со сравнительно высокими обратными токами возможен разогрев. Начавшийся разогрев, в свою очередь, приведет к увеличению обратного тока. Таким образом, в pn -переходе возникает положительная обратная связь, ведущая к возникновению тепловой неустойчивости – тепловому пробою.
Часто на ВАХ диодов наблюдается участок отрицательного дифференциального сопротивления (рис.5.16).

|
| Рис. 5.16. ВАХ диодов при пробое |
Если не принять специальных мер для ограничения тока, то диод выходит из строя. Предпосылкой для возникновения теплового пробоя служат большие значения обратного тока, поэтому этот тип пробоя легче возникает в приборах, изготовленных на основе материалов с небольшой шириной запрещенной зоны. Так, например, в высоковольтных германиевых диодах он может иметь место уже при комнатных температурах. В диодах на основе Si и GaAs он может иметь место при высоких температурах, когда значения обратных токов становятся большими.
5.7 Влияние сопротивления базы на ВАХ pn -перехода. Полупроводниковый диод
Полупроводниковым диодом называют нелинейный электронный прибор с двумя выводами.
До сих под мы говорили об идеальном pn -переходе, то есть не учитывали падение напряжения на квазинейтральных областях. При приложении напряжения к реальному полупроводниковому диоду, часть напряжения падает на контактах (см. подраздел 4.3), если же контакты омические, то на квазинейтральных областях. При условии, что одна квазинейтральная область – эмиттер - (в нашем случае p-область) легирована сильнее другой области (базы), особую роль играет сопротивление последней.
При протекании тока I через диод падение напряжения на базе  . Величина сопротивления базы
. Величина сопротивления базы  зависит от удельного сопротивления базы и геометрии растекания тока. Для плоскостных диодов, линейные размеры pn -перехода в которых много больше толщины базы, сопротивление базы определяется простым соотношением (см. раздел 2):
зависит от удельного сопротивления базы и геометрии растекания тока. Для плоскостных диодов, линейные размеры pn -перехода в которых много больше толщины базы, сопротивление базы определяется простым соотношением (см. раздел 2):
 , ,
| (5.57) |
где  – удельное сопротивление,
– удельное сопротивление,  – толщина базы, зависящая от напряжения смещения.
– толщина базы, зависящая от напряжения смещения.
Падение напряжения на ОПЗ pn -перехода можно найти из формулы Шокли (5.42):
 , ,
| (5.58) |
тогда полное падение напряжения на диоде
 , ,
| (5.59) |
Прямая ветвь ВАХ, соответствующая этому выражению, показана на рис. 5.17, 5.18.

| 
|
| Рис. 5.17 ВАХ с учетом сопротивления базы в линейном масштабе | Рис. 5.18 Прямая ветвь ВАХ полупроводникового диода в полулогарифмическом масштабе |
На рис. 5.19 – прямая ВАХ диода в полулогарифмическом масштабе (значение тока откладывается в логарифмическом, а значение напряжения – в линейном масштабах). На нем показан способ графического определения значений тока насыщения и генерационно-рекомбинационного.
Толщина базы  в свою очередь влияет на закон распределения инжектированных носителей и диффузионных токов. В самом деле, экспоненциальное распределение, представленное в формулах справедливо для длинной базы, то есть при
в свою очередь влияет на закон распределения инжектированных носителей и диффузионных токов. В самом деле, экспоненциальное распределение, представленное в формулах справедливо для длинной базы, то есть при  . В случае короткой базы
. В случае короткой базы  следует использовать выражения, аналогичные представленным ранее:
следует использовать выражения, аналогичные представленным ранее:
 , ,
| (5.60) |
или:
 . .
| (5.61) |
Аналогичные уравнения могут быть получены для электронов в p-области и токовых зависимостей.
5.8 Выпрямление на полупроводниковом диоде
Основная задача полупроводникового диода – выпрямление переменного (в частности синусоидального) тока, то есть выделение постоянной его составляющей. Выпрямительные или вентильные свойства полупро-водникового диода определяются его ВАХ (рис. 5.20).

|
| Рис. 5. 20 ВАХ идеализированного выпрямляющего устройства |
ВАХ такого идеализированного выпрямляющего устройства можно охарактеризовать значениями обратного тока и прямого напряжения. Реальные ВАХ диодов представлены на рис. 5.21.

|
| Рис. 5.21. ВАХ реального pn -перехода |
|
|